最後和大家分享空洞的審核標準以及監測空洞的方法。
根據IPC-A-610D, Class 1, 2, & 3 產品Acceptable的標準是: 25% or less voiding of the ball X-Ray image area. 請注意,這裡是指“X-Ray Image Area”, 是一個影像圖面積的佔有百分比,不是真實體積佔有的百分比。
在影像圖片中,很有可能有些空洞的影像被別的更大的空洞完全遮蓋住了,或是重疊了,所以沒有計算上。況且,正如上篇“空洞對可靠性的影響”所說的,空洞的大小很有可能沒有空洞所在的位置重要。 但是這個是目前業界最普遍的使用方法。

關於各種空洞的監測方法,Raiyo和大家詳細分析了這五种:
1. 2D Transmission X-Ray. 目前業界最流行的方法,但是正如Raiyo總結的,這種方法不能準確測出voids所在的位置,大小,數量等。
2. 3D CT X-Ray. 測試voids的黃金工具。但是慢,對大產量的生産,可能會成爲降低生産效率的瓶頸。
3. X-Ray Laminography. 最快的測試方法。但是準確性有待提高,一般作爲大產量pass/fail的衡量工具。
4. Cross-Section. 對焊點有破壞性,慢,通常在實驗室使用。
5. Ball Shear. 常作爲檢測BGA package land to surface interface的voids工具。
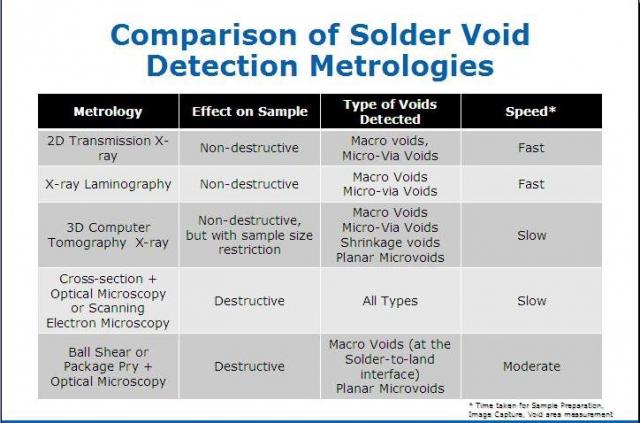
至此,完結! Cheers!
Picture, table, and Reference: Raiyo’s SMTA Voids in Solder Joints Presentation
Raiyo Aspandiar 是Intel公司資深工藝工程師,負責組裝工藝。 他曾在行業内發表25篇論文和擁有15項美國專利。Raiyo也是SMTA的技術委員會成員,和榮獲2009年SMTA傑出技術獎!2005年,Raiyo在深圳IPC技術研討會上與大家分享過關于焊點中的空洞。 Raiyo的郵件是 raiyo.f.aspandiar@intel.com


