Semiconductor Packaging & Assembly
2.5D and 3D Packaging
To boost performance, integration, and system capabilities in semiconductor devices, the industry is increasingly adopting 2.5D and 3D packaging. This consolidates multiple integrated circuits (ICs) into a single package, a crucial trend in miniaturization during an era of heterogeneous integration. As a global leader in designing, formulating, manufacturing, and supplying semiconductor-grade fluxes, pastes, and related materials, Indium Corporation is the proven expert for your packaging needs.
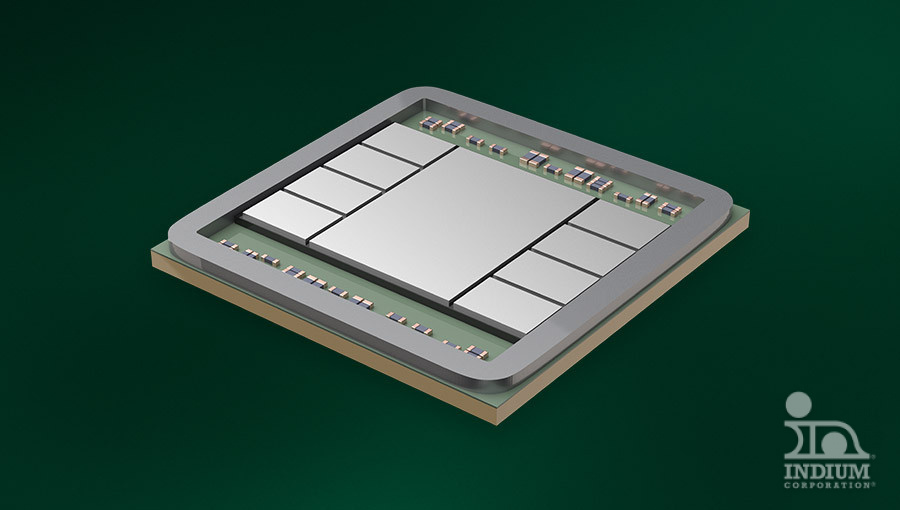

Overview
Advancing Semiconductor Integration with the Power of 2.5D and 3D Packaging
More than Moore, 2.5D and 3D packaging are sophisticated semiconductor integration technologies aimed at enhancing performance and system capabilities. These techniques enable the incorporation of diverse process nodes into a single package. In 2.5D packaging, dies are positioned side by side, while 3D packaging involves stacking the dies vertically. Indium Corporation collaborates with top-tier customers and equipment partners to innovate and refine materials and assembly processes in this rapidly evolving realm.
Benefits
Driving Innovation in Packaging Materials Through Strategic Collaborations
Strategic Partnerships
Leading customers and equipment partners help Indium Corporation develop cutting-edge materials tailored for advanced packaging requirements.
Proven
Process-proven materials are already in use for advanced packaging assembly.
High Yield
Our robust and stable materials achieve the desired yield, especially in challenging packaging assembly processes.
Excellent Technical Service
We provide the support you need to select materials and optimize processes to achieve high-yield.
Related Applications
Related Markets
2.5D and 3D packaging techniques are widely utilized and have a significant impact across industries.
Your Success
is Our Goal
Optimize your processes with the latest materials, technology, and expert application support. It all starts by connecting with our team.