Ich wurde diese Woche gebeten, einen Beitrag zum kommenden IPC-Handbuch (IPC-CH-65 HDBK) über den Abschnitt über Verunreinigungen und deren Auswirkungen auf gedruckte Verdrahtungsbaugruppen (PWAs) zu leisten. Es gibt einen klaren Übergang der Technologie von der Standard-SMT/Leiterplatten-Arena in die Halbleitermontage: speziell in die Flip-Chip-, Microbumps- und TSV-Montage. Die Terminologie beginnt jedoch zu kollidieren": Begriffe, die den Halbleiterherstellern vertraut sind, müssen nun verstanden und Teil des Lexikons von Halbleiter-Packaging-Ingenieuren werden, die aus der SMT-Branche kommen. Daher möchte ich mit diesem Blogbeitrag, der auf einem Vortrag basiert, den ich auf der IWLPC-Tagung 2009 gehalten habe, für ein breiteres Publikum etwas Klarheit schaffen.
Elektrochemische Migration (ECM)
ECM ist gekennzeichnet durch die Bewegung von Metallionen ZWISCHEN benachbarten Metallleitern, um Dendriten zu bilden. Die wichtigsten Steuerungsparameter sind hier:
-Feuchtigkeitoder hohe Luftfeuchtigkeit, gemessen als %RH
-Vorhandenseinvon mobilen Metall-Ionen
-Einhohes Potentialgefälle, ausgedrückt in Volt pro Längeneinheit (z.B. V/cm)
Hohe Temperaturen können das Problem ebenfalls verschärfen. Die hydratisierten Metallionen, die positiv geladen sind, wandern zur Kathode (-ve) und bilden einen Dendriten, eine nadel- oder baumzweigartige Metallstruktur. Der Dendrit ist der wichtigste visuelle Indikator für ECM. 
Elektromigration (EM)
EM hingegen entsteht INNERHALB eines Metallleiters, wenn eine große Anzahl von Elektronen mit hoher Geschwindigkeit auf Metallatome auftrifft und diese durch einfache Impulsübertragung verschiebt. Die wichtigsten Faktoren, die EM beeinflussen, sind:
-Hohe Temperatur
-Vorhandenseinvon beweglichen Metallatomen
-einehohe Stromdichte, ausgedrückt in Ampere pro Flächeneinheit (z. B. A/cm2)
Es ist wichtig zu beachten, dass Luftfeuchtigkeit oder andere Umgebungsfeuchtigkeit keinen Einfluss auf EM hat, da EM im Inneren der Metallverbindung auftritt.
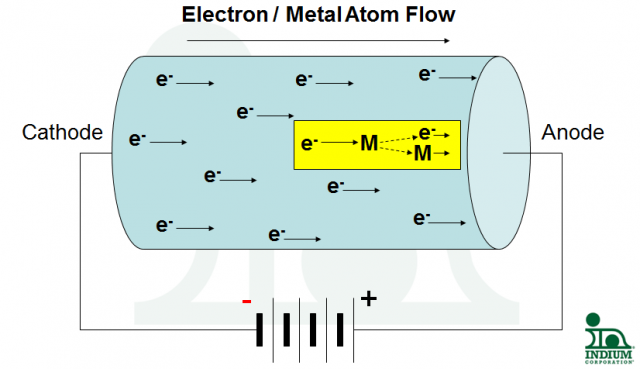
Der primäre visuelle Indikator für EM ist das Vorhandensein von Hohlräumen an Punkten in einer Metallverbindung in der Nähe der Anode (+ve), oft dort, wo die Stromdichte am größten ist (der "current crowding"-Effekt - siehe unten).
Die Hohlräume sind in der Regel im Inneren der Verbindung zu sehen und können schließlich zum thermischen Durchgehen und zum Versagen der Verbindung führen, da die effektive Querschnittsfläche der Verbindung mit der Zeit schrumpft und die Stromdichte steigt.
Ich hoffe, dass diese Erklärung klar ist und Sinn macht.
Zum Wohl! Andy




