우리 모두 알다시피, 반도체 패키징 구조가 더욱 복잡해지고 전력 밀도가 증가함에 따라 열 관리 솔루션을 찾는 것이 반도체 업계에서 점점 더 중요해지고 있는 동시에 더욱 어려운 과제가 되고 있습니다. 반도체 디바이스의 전력 밀도가 증가하고 접합 온도가 상승함에 따라 열 방출은 종종 큰 관심사이며, 이는 반도체 디바이스의 성능과 신뢰성에 악영향을 미칠 수 있습니다.
열 성능 저하로 인해 반도체 장치의 성능이 악영향을 받지 않도록 열 관리 솔루션을 개발하려면 효과적인 도구와 기능이 필요합니다. 컴퓨터 시뮬레이션과 물리적 열 테스트 모두 중요한 역할을 합니다.
컴퓨터 시뮬레이션은실제 프로토타입을 제작하지 않고도 다양한 설계 옵션을 평가하고 민감도 분석을 수행하여 설계자가 여러 옵션 중에서 최적의 솔루션을 선택할 수 있도록 도와줍니다. 이는 반도체 장치와 같은 신제품의 초기 개발 단계에서 매우 유용하며 제품 개발 속도를 높이는 데 큰 도움이 됩니다. 컴퓨터 시뮬레이션의 장점은 분명하며, 이러한 이유로 컴퓨터 시뮬레이션은 지난 수년간 반도체 디바이스 제품 개발의 도구로 광범위하게 활용되어 왔습니다.
그러나 컴퓨터 시뮬레이션에는 일반적으로 몇 가지 중요한 한계가 있기 때문에 컴퓨터 시뮬레이션이 물리적 측정과 테스트를 완전히 대체할 수 있다고 말할 수는 없습니다. 우선, 컴퓨터 모델링은 경계 조건, 주변 조건, 재료 특성 등과 관련하여 항상 일정한 가정을 전제로 해야 합니다. 특히 반도체 패키징 구조가 복잡해짐에 따라 복잡한 구조를 단순화해야 하는 경우가 많습니다. 이기종 통합은 반도체 패키지의 열 성능을 위해 로컬 에코시스템에서 매우 중요한 요소인 다양한 재료, 상호 연결 및 인터페이스가 단일 패키지에 포함되는 경우가 많기 때문에 이러한 문제를 더욱 어렵게 만듭니다.
또한 컴퓨터 모델링은 정적인 문제를 다루는 경우가 많지만 실제 문제는 항상 동적인 문제입니다. 예를 들어, 열 인터페이스 재료(TIM)와 같은 재료 특성은 다양할 수 있으며 환경 조건에 따라 시간이 지남에 따라 변할 수 있습니다. 펌프 아웃은 열 및 기계적 하중 하에서 발생할 수 있습니다. 컴퓨터 시뮬레이션으로 이러한 모든 변수를 정확하게 고려하기는 어려운 경우가 많습니다. 또한 칩, 방열판, TIM 등 구조의 다양한 요소에는 불균일성이 존재하며 컴퓨터 시뮬레이션에서 이러한 모든 실제 불균일 조건을 정확하게 설명하기는 어렵습니다.
매우 중요한 것은 패키지 구조의 다양한 요소와 재료(예: 다이, TIM 및 방열판) 사이의 인터페이스가 열 방출에 중요한 역할을 하지만 열 저항 측면에서 정확하게 특성화하기가 매우 어렵고 컴퓨터 모델링은 이러한 복잡한 패키징 구조를 단순화해야 하는 경우가 많습니다. 실제 기능성 반도체 소자는 열 거동 측면에서 매우 동적이며, 특히 재료의 특성과 소자 온도 간에 상호 작용하는 효과(예: 재료의 특성이 직접 영향을 미치는 소자 온도)가 있는 경우 이러한 동적이고 상호 작용하는 현상을 컴퓨터 모델링으로 정확하게 포착하기 어려울 수 있습니다.
실제로 고장 모드와 성능 저하 메커니즘은 종종 복잡하며, 컴퓨터 모델링은 일반적으로 몇 가지 알려진 고장 모드에 초점을 맞추고 있습니다. 특정 반도체 패키지의 예상치 못한 고장 모드는 때때로 심각한 위험을 초래할 수 있습니다. 따라서 검증을 위해서는 항상 물리적 테스트가 필요합니다.
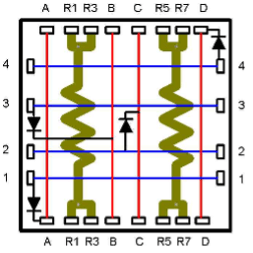
물론 열 측정 및 테스트에는 자체적인 어려움이 있으며, 특히 실제 반도체 디바이스가 개발 및 제조되기 전에 테스트를 수행해야 하는 경우 몇 년이 걸릴 수 있습니다. 업계에서는 칩을 개발하면서 열 측정 및 테스트가 필요한 열 관리 솔루션을 개발하는 것이 관행으로 자리 잡았습니다. 열 테스트 칩(TTC)과 열 테스트 차량(TTV)은 이러한 동시 환경에서 중요한 역할을 합니다(그림 1 및 2).
TTC는 칩의 전력 입력 및 전력 밀도 분포(일반적으로 불균일하지 않음)를 근사화할 수 있어야 하며, 동시에 전체 다이의 온도 분포(통합 센서 사용)를 실시간으로 정확하게 감지(분해능 1mmx1mm 이하)할 수 있어야 합니다.
흥미로운 점은 TTC의 크기가 1mm2 정도로 작기 때문에 첨단 반도체 디바이스용 칩렛의 열 성능을 시뮬레이션하는 데 매우 유용할 수 있다는 것입니다.
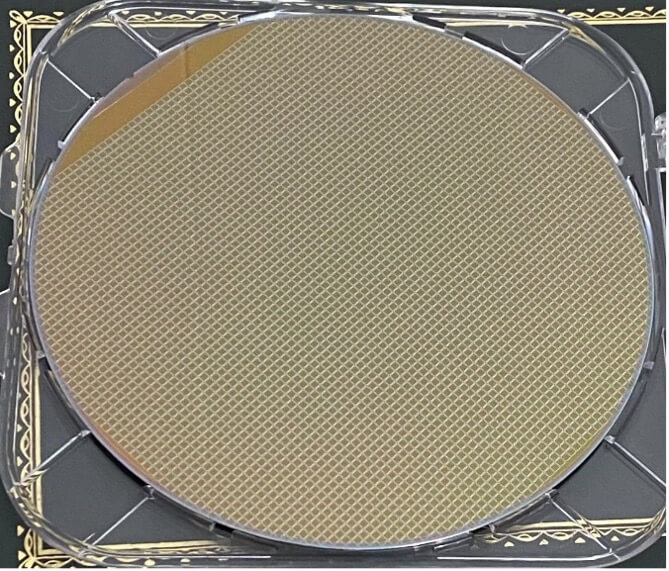
패키지 TTC로 구성된 TTV는 의도한 패키지 구조를 나타내도록 구성해야 하며, 전체 시스템의 방열 및 열 성능에 영향을 미칠 수 있는 실제 TIM, 방열판 및 기타 실제 부품을 사용하여 구성 및 제조해야 합니다. 대체 열 관리 솔루션을 비교하려면 JEDEC JESD51 시리즈 표준과 같은 산업 표준을 엄격하게 준수해야 합니다. 또한 TTV는 표준에 정의된 패키지 구조와 다른(그리고 더 복잡한) 실제 패키지 구조로 특정 애플리케이션에 맞게 구성할 수도 있습니다. 따라서 TTV는 매우 다양한 종류가 있을 수 있습니다(그림 3).
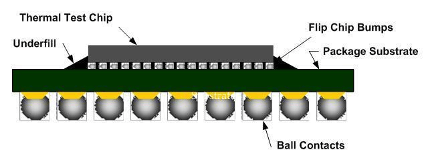
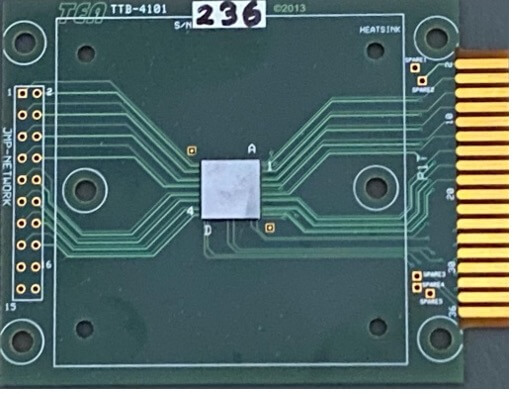
열 부하 보드(TLB)는 전자 시스템의 기계, 전기 및 열 측면을 동시에 설계하기 위한 시스템 수준의 열 관리 설계 툴입니다(그림 5). TLB는 일반적으로 저항 및 TTC 열원 시뮬레이터(HSS)를 사용하여 실제 열 부하 조건에 대한 근접한 물리적 시뮬레이션을 제공하도록 맞춤 설계됩니다.
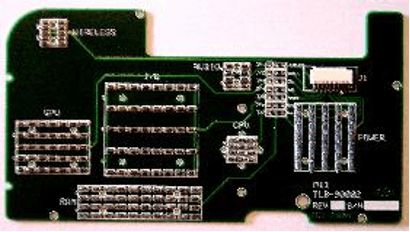
이러한 도구는 반도체 디바이스 및 패키지의 열 성능을 특성화하는 데 매우 유용합니다. TTC와 TTV를 사용하여 실제 환경(전원 입력, 주변 조건, 공기 흐름 등)에서 열 측정 및 테스트를 수행함으로써 칩의 공간적, 시간적 온도 분포(핫스팟 포함)를 특성화하고 전체 패키지의 열 성능을 평가하고 다양한 패키지 설계, TIM, 방열판 등을 평가하고 컴퓨터 모델링을 보정 및 검증할 수 있습니다.
전반적으로 반도체 디바이스 제품 개발의 목표는 비용, 크기, 무게, TTM에 영향을 미치는 과잉 설계나 신뢰성 및 제품 성능에 영향을 미치는 과소 설계가 아닌 "최적의 설계"를 달성하는 것입니다. 이를 달성하는 유일한 방법은 열 측정 및 테스트와 함께 컴퓨터 시뮬레이션("디지털 트윈")을 "물리적 시뮬레이션"("물리적 트윈")과 함께 효과적으로 사용하는 것입니다.
자세한내용은동카이 상관 박사에게 문의하세요.



