첨단 패키징은 이기종 통합을 향한 다양한 상호 연결 기술과 함께 계속 발전해 왔습니다. 첨단 패키지의 수율을 최적화하기 위해 다양한 조립 공정이 사용되고 있으며, 시스템 인 패키지(SiP) 및 소형 모듈의 조립 공정에서 직면한 많은 문제를 해결하기 위해 혁신적인 첨단 패키징 재료의 개발이 필요합니다.
첨단 포장 재료에 대한 도전 과제
인터커넥트가 조밀하게 패키징된 더 큰 다이 크기와 이와 관련된 더 좁은 피치 및 더 작은 범프는 조립 공정에서 뒤틀림으로 인한 오픈 조인트, 좁은 간격으로 인한 플럭스 잔류물 제거 문제 등 여러 가지 문제를 야기합니다. 예를 들어, 비대칭 범프 설계와 함께 더 크고 얇은 실리콘 다이와 얇은 기판으로 인한 뒤틀림은 패키징에서 우수한 수율을 달성하는 데 있어 일반적인 과제를 제시합니다. 이러한 문제를 극복하기 위해 열 압축 본딩(TCB), 레이저 보조 본딩(LAB), 플럭스 없는 포름산 리플로우가 사용됩니다(그림 1). TCB 및 LAB 공정은 일반적으로 웨이퍼 또는 기판을 100~150°C의 가열된 받침대 위에 장시간 유지하는데, 본딩 공정에 플럭스를 사용하는 경우 이러한 조건은 경화된 플럭스 잔류물에 대한 세척 문제를 야기할 수 있습니다.
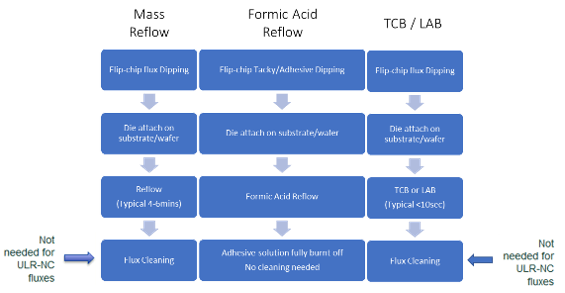
따라서 웨이퍼/다이 본딩을 위한 새로운 플럭스 배합과 접착제가 개발되었습니다. 예를 들어 반도체 등급의 초저잔류(ULR) 노클린 플립칩 플럭스 사용으로의 전환은 납땜 공정 후 남는 플럭스 잔류물이 최소화(10% 미만, 최저 1%)되어 이러한 문제를 극복하기 위한 솔루션 중 하나입니다. ULR 플럭스는 최소한의 플럭스 잔류물이 후속 공정에 사용되는 언더필 또는 몰딩 재료와 호환되므로 세척할 필요 없이 적절한 습윤성과 접착력을 제공하면서 부식 위험을 제거하여 우수한 조인트를 형성하는 데 활용되었습니다.
플럭스가 없는 포름산 리플로우("플럭스리스")의 경우 공정 중에 다이를 제자리에 고정하기 위해 점착제 또는 접착제를 사용하며, 이 점착제는 후속 공정과 호환되지 않는 잔류물을 남기지 않아야 합니다.
팬아웃 웨이퍼 레벨 패키징(FOWLP)의 경우, 일반적으로 볼 부착 공정을 통해 인터커넥트 범프를 형성합니다. 위에서 언급한 뒤틀림 문제와 플럭스 제거 공정의 효율성 외에도 폴리이미드, BCB, PBO의 새로운 유전체 폴리머 코팅과의 호환성은 또 다른 관심 분야입니다. 유전체 층의 박리 및 잔류물은 온도의 영향을 받는 서로 다른 재료 간의 비호환성으로 인해 흔히 발생하는 문제 중 일부입니다. 다양한 온도에서 플럭스 재료와 유전체 층 간의 상호 작용에 대한 철저한 연구 끝에 새로운 유전체 폴리머 코팅과 호환되는 새로운 플럭스 재료가 개발되었습니다.
SiP의 과제
고밀도 SiP 애플리케이션을 위한 솔더 페이스트 증착은 매우 까다로워졌습니다. SiP 및 이기종 통합을 위한 반도체 패키지의 소형화 및 기능 고밀도화에 대응하여, 미세 분말의 넓은 표면적으로 인한 산화 문제를 극복하여 초미세 피치 인쇄용으로 설계된 종합적인 솔더 페이스트 포트폴리오는 6타입에서 8타입에 이르는 미세 분말을 사용하여 개발되었습니다(그림 2). 100µm 이하의 미세 피처 솔더 페이스트 애플리케이션의 경우, 일관된 솔더 페이스트 증착과 우수한 솔더링 성능을 달성하려면 미세 솔더 합금 분말, 플럭스 배합 및 솔더 페이스트 유변학 품질이 매우 중요합니다. 이러한 중요한 기능은 일관된 인쇄 성능으로 보이드와 슬럼프를 줄이고 우수한 습윤 성능과 우수한 스텐실 인쇄 전사 효율을 결합하여 가장 광범위한 공정 요구 사항을 충족하는 데 도움이 됩니다. 솔더 페이스트 인쇄가 불가능한 특정 패키징 설계의 경우, 마이크로 디스펜싱 또는 정밀 분사를 대안으로 사용할 수 있으며, 80µm 피처 크기까지 일관된 증착이 가능합니다.

새로운 솔더의 개발은 이기종 통합을 위한 중요한 원동력이기도 합니다. 솔더 계층 구조가 필요한 리플로우 사이클이 다른 경우 SiP에는 다양한 용융 온도를 가진 합금이 필요할 수 있습니다. 또한 용융 온도가 낮은 솔더는 특히 얇은 다이/기판의 경우 휨을 더 잘 제어할 수 있을 뿐만 아니라 열에 민감한 부품의 열 노출을 최소화할 수 있습니다. 자동차 모듈 및 기타 까다로운 애플리케이션을 위해 신뢰성이 강화된 합금도 개발되었습니다.
전력 전자 및 열 관리
고전력 디바이스(예: GaN)를 위한 누설 전류가 감소된 저알파 고납땜 페이스트, 고온 납을 사용하지 않는 대안으로 혼합 납땜 분말 기술을 사용하는 Durafuse™ HT(특허 출원 중) 등 전력 전자제품용 소재 솔루션 포트폴리오가 개발되어 현재의 고납땜 공정과 유사한 납땜 공정을 사용하면서도 고납보다 우수한(또는 최소한 비슷한) 결합 전단 강도, 열 순환 신뢰성, 열 전도성을 제공하는 제품들이 출시되고 있습니다.
Ag 및 Cu 소결 페이스트 배합의 개발로 결합 전단 강도 및 열 전도성을 비롯한 특성이 크게 향상된 전력 전자 제품의 다이 부착, 패키지 부착 및 유사 응용 분야를 위한 솔루션이 탄생했습니다(그림 3). 금속 로딩이 높은 재료는 소결 공정 후 유기 잔류물을 최소화하도록 설계되었으며, 다양한 표면 마감(예: Ag, Cu, Au)에서 무압 및 가압 소결을 위한 빠른 소결 및 강력한 접합 강도를 제공합니다. 사전 건조 및 가압 소결 공정을 통해 낮은 보이드와 다공성을 달성했습니다.
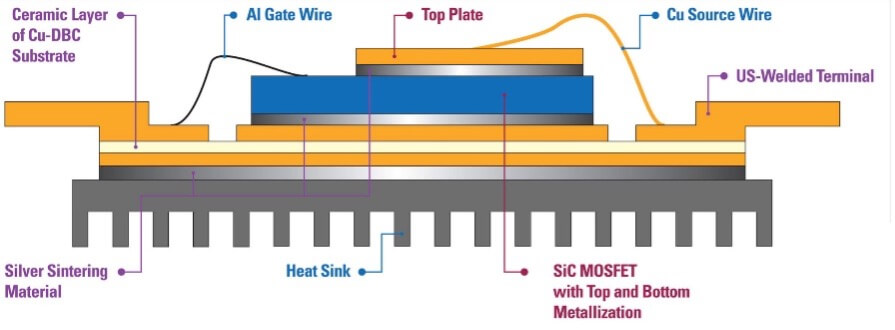
반도체 디바이스의 전력 밀도가 증가하고 접합 온도가 상승함에 따라 열 관리 문제를 해결하기 위해 다양한 열 전도성과 형태를 갖춘 여러 열 인터페이스 재료(TIM) 솔루션이 수년에 걸쳐 개발되었습니다. 인듐 기반 TIM과 갈륨 기반 TIM을 포함한 금속 TIM은 까다로운 애플리케이션에서 점점 더 많이 사용되고 있습니다. 갈륨 기반 액체 금속 TIM은 다양한 표면을 가진 강력한 습윤 특성과 "누설"을 제거할 수 있는 가능성으로 인해 열 관리의 새로운 가능성을 열어가고 있다는 점이 흥미롭습니다.



