アドバンスト・パッケージングは、様々な相互接続技術が異種集積化に向けて進化し続けている。先進パッケージの歩留まりを最適化するためにさまざまな組立プロセスが使用される一方で、システム・イン・パッケージ(SiP)や小型化モジュールの組立プロセスで直面する多くの課題に対処するために、革新的な先進パッケージング材料の開発が必要とされている。
先進包装材料の課題
高密度にパッケージングされた相互接続を伴うダイサイズの大型化、およびそれに伴う狭いピッチと小さなバンプは、特に狭いスペーシングに起因する反りによるオープンジョイントやフラックス残渣除去の課題など、アセンブリプロセスにおける課題を提示します。例えば、大きく薄いシリコンダイと薄い基板による反りや、非対称のバンプ設計は、パッケージングで良好な歩留まりを達成するための共通の課題となっています。このような課題を克服するために、熱圧着(TCB)、レーザーアシストボンディング(LAB)、フラックスを使用しない蟻酸リフローが用いられている(図1)。TCBとLABプロセスは通常、ウェーハまたは基板を100~150℃の加熱された台座上に長時間保持する。接合プロセスにフラックスが使用される場合、この条件は硬化したフラックス残渣の洗浄の問題を引き起こす可能性がある。
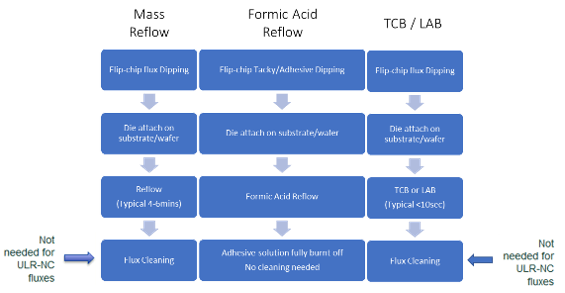
そのため、ウェハ/ダイ接合用の新しいフラックス配合や接着剤が開発されてきた。例えば、半導体グレードの超低残渣(ULR)無洗浄フリップチップ・フラックスの使用へのシフトは、はんだ付けプロセス後に残るフラックス残渣が最小限(10%未満、1%程度)であるため、これらの課題を克服するための解決策の1つです。ULRフラックスは、腐食リスクを排除すると同時に、十分な濡れ性とタックを提供し、洗浄の必要なく良好な接合部を形成するために利用されています。最小限のフラックス残渣は、後工程で使用されるアンダーフィルや成形材料と互換性があるためです。
フラックスを使用しない(「フラックスレス」)ギ酸リフローでは、プロセス中にダイを所定の位置に保持するために粘着性または接着剤が使用され、この粘着性薬剤は、その後のプロセスに不適合となるような残留物を残してはならない。
ファンアウトウェーハレベルパッケージング(FOWLP)では、通常、ボールアタッチプロセスが相互接続バンプの形成に関与する。前述の反り問題とフラックス除去プロセスの有効性以外に、ポリイミド、BCB、PBOといった新しい誘電体ポリマーコーティングとの互換性も懸念事項の一つです。誘電体層上の層間剥離や残留物は、温度の影響下で異なる材料間の非互換性に起因する一般的な問題の一部です。異なる温度におけるフラックス材料と誘電体層との相互作用を徹底的に研究した結果、新しい誘電体ポリマーコーティングに適合する新しいフラックス材料が開発されました。
SiPの課題
高密度SiPアプリケーション用のソルダーペーストの成膜は非常に難しくなっています。SiPやヘテロジニアスインテグレーション向け半導体パッケージの微細化・機能高密度化に対応するため、微細粉末の大きな表面積による酸化の課題を克服し、タイプ6からタイプ8までの微細粉末を使用した超ファインピッチ印刷用に設計されたソルダーペーストの包括的なポートフォリオが開発されました(図2)。100µm以下の微細はんだペーストアプリケーションでは、微細はんだ合金粉末の品質、フラックス配合、はんだペーストのレオロジーが、安定したはんだペースト析出と良好なはんだ付け性能を達成するために極めて重要です。これらの重要な特徴は、ボイドやスランプの発生を抑え、安定した印刷性能を実現し、優れた濡れ性能と優れたステンシル印刷の転写効率を組み合わせることで、幅広いプロセス要件を満たします。ソルダーペーストの印刷が不可能なパッケージング設計の場合、マイクロディスペンシングや精密ジェット印刷を代替手段として使用することができ、80µmのフィーチャーサイズまで安定した成膜が可能です。

新しいはんだの開発も、異種集積を可能にする重要な要素である。はんだ階層を必要とする異なるリフロー・サイクルが存在する場合、SiP には異なる溶融温度の合金が必要になる可能性があります。さらに、溶融温度の低いはんだは、特に薄型ダイ/サブストレートの反り制御を改善し、熱に敏感な部品の熱曝露を最小限に抑えることができます。信頼性を向上させた合金も、車載モジュールやその他の要求の厳しい用途向けに開発されています。
パワーエレクトロニクスと熱管理
パワーエレクトロニクス向けには、高電力デバイス(GaNなど)向けにリーク電流を低減した低アルファ高Pbソルダーペーストや、高温Pbフリー代替品として混合はんだ粉末技術を用いたDurafuse™ HT(特許出願中)など、材料ソリューションのポートフォリオが開発されており、現行の高Pbはんだ付けプロセスと同様のはんだ付けプロセスを使用しながら、接合せん断強度、熱サイクル信頼性、熱伝導率が高Pbよりも優れている(または少なくとも高Pbに匹敵する)。
AgおよびCu焼結ペーストの配合開発により、接合せん断強度や熱伝導率などの特性が大幅に向上した、パワーエレクトロニクス用のダイ・アタッチ、パッケージ・アタッチ、および同様のアプリケーション向けのソリューションが生まれました(図3)。高金属担持材料は、異なる表面仕上げ(Ag、Cu、Auなど)において、無加圧焼結や加圧焼結で高速焼結と強力な接合強度を実現し、焼結プロセス後に有機残留物を最小限に抑えるように設計されています。予備乾燥および加圧焼結プロセスにより、低ボイドおよび低気孔率が達成されています。
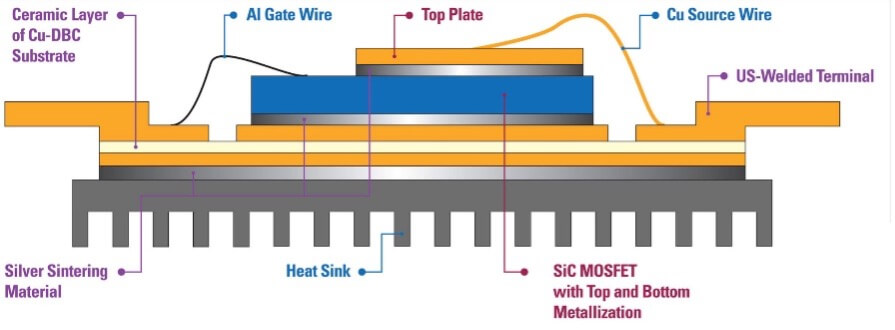
半導体デバイスの高電力密度化と接合部温度の上昇に伴う熱管理上の課題に対処するため、幅広い熱伝導率と形状を持つ複数のサーマルインターフェイス材料(TIM)ソリューションが長年にわたって開発されてきました。インジウム系TIMやガリウム系TIMなど、要求の厳しい用途では金属TIMの使用が増加している。ガリウムベースの液体金属TIMは、さまざまな表面との強固な濡れ特性と、"リーク "をなくすことが期待できることから、熱管理における新たな可能性を開いていることは興味深い。



