半導体パッケージング&アセンブリ
BGAボール・アタッチ
インジウムコーポレーションは、半導体製造の重要なステップであるボールグリッドアレイ(BGA)ボールアタッチプロセスをリードしています。当社の革新的なBGAはんだフラックス材料は、基板の準備から最も重要なボールアタッチプロセスまで、すべての段階で最適な性能を確保するように設計されています。インジウムコーポレーションは、優れた結果をもたらす実証済みのソリューションでお客様をサポートします。
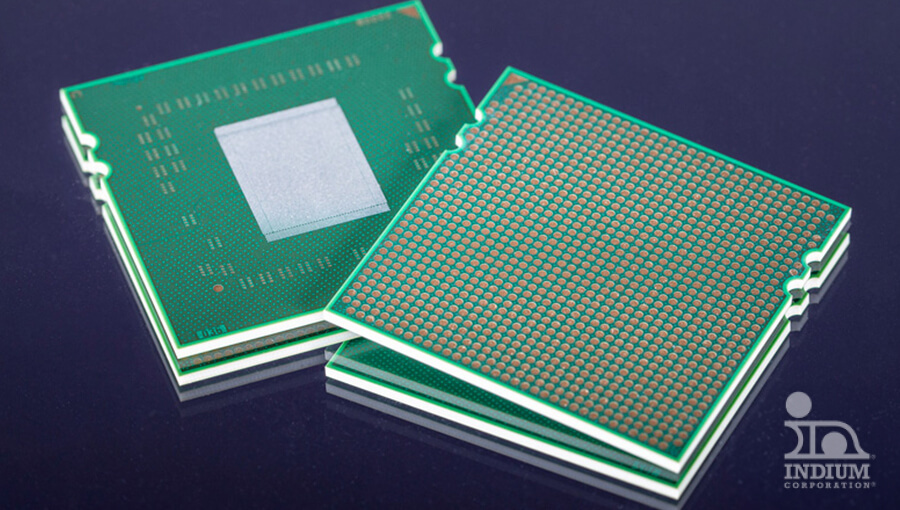

概要
実績のある革新的なボールアタッチフラックスでBGAパッケージの性能を向上
BGAパッケージのボールアタッチプロセスは、多くの場合、ディッピングトレイからピン転写によってフラックスを塗布することから始まる。次に、球状のはんだ(はんだボール)をフラックスの中に入れ、アセンブリ全体をリフローします。このプロセスを成功させ、最終パッケージの長期信頼性を確保するためには、信頼性の高いボールアタッチフラックスが不可欠です。インジウムコーポレーションは、高性能で標準的な水溶性ボールアタッチフラックスを提供し、デリケートなデバイス用に特別に設計された、フラックスデポジット上への初の超低残渣、無洗浄ボールアタッチフラックスで業界をリードしています。
メリット
最適なパフォーマンスを実現する先進のボールアタッチ・フラックス・ソリューション
強いウェット
ボール・アタッチ・フラックス・ソリューションは、汚れや酸化が著しい金属表面でも、あらゆる金属表面で最適な濡れ性を保証します。
簡単にクリーニング可能
水洗フラックス残渣は、室温で純度の高い純水を使用してリフロー後に簡単に洗浄できるため、化学薬品や加熱水を使用する必要がありません。
一貫性
ピン転写であれ、印刷であれ、一定したフラックス量が長時間維持される。
ノー・クリーン
超低残渣ボール・アタッチ・フラックスは、ますます洗浄が難しくなっているデリケートなデバイスに最適です。
関連商品
関連アプリケーション
関連市場
Back to the Basics: Flux
During my first few weeks as a Technical Support Engineer at Indium Corporation, I researched extensively and consulted with my team to find out when flux should be used and why it’s essential to
システム・イン・パッケージのための革新的先端パッケージング材料の開発
アドバンスド・パッケージングは、さまざまな相互接続技術がヘテロジニアス(異種接合)に向かって進化し続けている。
ボールグリッドアレイの一般的な故障とその回避方法
ボール・アタッチ・プロセスは、フリップ・チップ・アセンブリや2.5Dおよび3Dのような他のプロセスほどエキサイティングではないことは認める。
WS-446HFのレオロジーはどのようにワンステップ洗浄を可能にするのか?
私のチームの製品ラインについて知ったとき、最初にググらなければならなかった用語のひとつが「レオロジー」だった。
半導体フラックスパート1
半導体製品になじみのない人の多くは、それを敷居の高いものと感じている。私もその一人だったが、今となっては、半導体のフラックスは、そのようなものではない、と理解している。
PC、タブレット、携帯電話は滅びない。
皆さん、パティとロブがまた冒険に出たようです。ちょっと覗いてみよう......。パティは大学時代から同じ2001年式のサーブ・ステーションワゴンに乗っていた。それは素晴らしい車だった。
Minimizing the Head-in-Pillow Defect in SMT Assembly
Phil Zarrow: This video is for those in the electronics assembly industry that want to minimize the head-in-pillow defect. It includes the solder paste properties that help overcome this challenge.
BGA Voiding in Electronics Assembly
Patty had to admit that the last few weeks were exciting. Her talk to US Army Rangers and Navy Seals on critical thinking went really well. Now, the local newspaper was asking her to comment on
ワンステップOSP BGAはんだ付けアプリケーション
The ball-attach process can be considered a trivial step when creating an FCBGA or similar package, but the final soldering step can be rather complex. There are several variables that impact the