半导体封装与装配
BGA 连接球
Indium Corporation leads the way in the ball grid array (BGA) ball-attach process, a critical step in semiconductor manufacturing. Our innovative BGA solder flux materials are designed to ensure optimal performance at every stage, from substrate preparation to the most critical ball-attach process. With Indium Corporation, you’re backed by proven solutions that drive superior results.
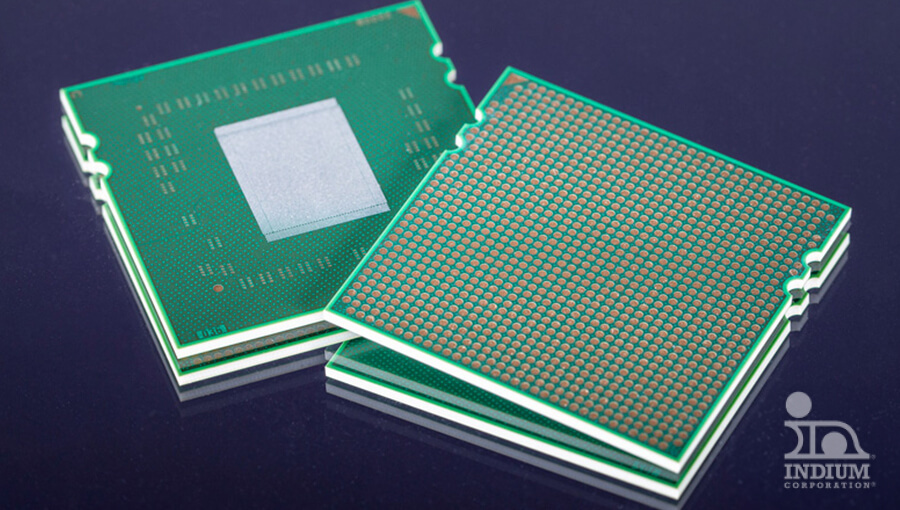

概述
利用久经考验的创新型滚珠连接助焊剂提高 BGA 封装性能
The ball-attach process for BGA packages starts with applying flux, often via pin-transfer from a dipping tray. Next, solder spheres (solder balls) are placed into the flux deposits, followed by reflow of the entire assembly. A reliable ball-attach flux is essential to ensure both the success of this process and the long-term reliability of the final package. Indium Corporation offers high-performance, standard water-soluble ball-attach flux and leads the industry with the first ultra-low residue, no-clean ball-attach flux, onto the flux deposits, specially designed for delicate devices.
益处
实现最佳性能的先进滚珠连接助焊剂解决方案
强力润湿
滚珠连接助焊剂解决方案可确保所有金属表面的最佳润湿效果,即使是有严重污染或氧化的金属表面也不例外。
易于清洁
水洗助焊剂残留物可在回流焊后使用室温下的纯去离子水轻松清洗,无需化学品或加热水。
一致性
无论是通过针脚传输还是印刷应用,都能在较长的时间内保持稳定的流量。
免清洗
超低残留球形助焊剂是越来越难清洁的敏感设备的最佳选择。
相关应用
您的成功
是我们的目标
利用最新材料、技术和专业应用支持优化您的流程。一切从与我们的团队联系开始。