No es ningún secreto que los materiales de interfaz térmica (TIM) de indio y soldadura de indio-plata muestran un gran potencial para maximizar el rendimiento térmico en aplicaciones de computación de alto rendimiento (HPC) e inteligencia artificial (IA). El indio puro, en concreto, cuenta por sí solo con una alta conductividad térmica (k = 86 W/mK). Las aleaciones de indio y plata que se utilizan habitualmente para los TIM de soldadura tienen una conductividad térmica ligeramente inferior, que depende de la concentración de plata en la aleación.
Gran parte del reto que plantea la implementación de estos materiales consiste en definir el proceso de soldadura. Pero antes incluso de pensar en el perfil térmico y su impacto en la formación de huecos o la fiabilidad, es importante utilizar las superficies soldables adecuadas para garantizar una unión TIM soldada resistente y fijada mecánicamente.
Este blog tratará sobre la actual pila de metalización para materiales basados en indio e indio-plata. Tras más de dos décadas de trabajo de desarrollo, se han realizado múltiples iteraciones sobre lo que debería colocarse tanto en la superficie del chip de silicio como en la superficie del disipador térmico o del difusor térmico integrado. Exploraremos lo que se utiliza actualmente y cómo las aplicaciones pasadas del indio puro han contribuido a nuestra comprensión actual de lo que hace que la soldadura basada en indio sea tan eficaz.
¿Por qué soldadura de indio o indio-plata TIM?
Antes de abordar la pila de metalización, analicemos por qué se utilizan materiales basados en indio o indio-plata para TIM1 y TIM1.5 en el ecosistema de IA, centros de datos y HPC. En estas aplicaciones, suele producirse una deformación significativa asociada a la superficie del chip de silicio donde se aplica el TIM. A medida que el chip se calienta y se enfría durante el funcionamiento, se produce una flexión dinámica constante debido al desajuste del coeficiente de expansión térmica (CTE) entre los materiales que componen el chip.
El indio puro, además de su alta conductividad térmica, es también un metal muy maleable y blando. Tiene un límite elástico muy bajo y es más propenso a la fluencia y la deformación en comparación con otras aleaciones de soldadura en estado sólido. El comportamiento mecánico del indio es lo que lo diferencia de la mayoría de las aleaciones de soldadura a base de estaño y los TIM grafíticos, ya que su flexibilidad es fundamental para la fiabilidad termomecánica de un dispositivo BGA, LGA, FC o ASIC acabado.
¿Cuál es la pila de metalización recomendada actualmente para TIM de soldadura?
Elegir la metalización correcta siempre es una cuestión importante en el ámbito de la SMT. La pila a la que se hace referencia aquí es nuestra recomendación personal para el uso de TIM1 y TIM1.5 y supone que el TIM de soldadura se implementará entre una superficie de silicio y un disipador térmico de cobre, una tapa o un difusor térmico integrado.
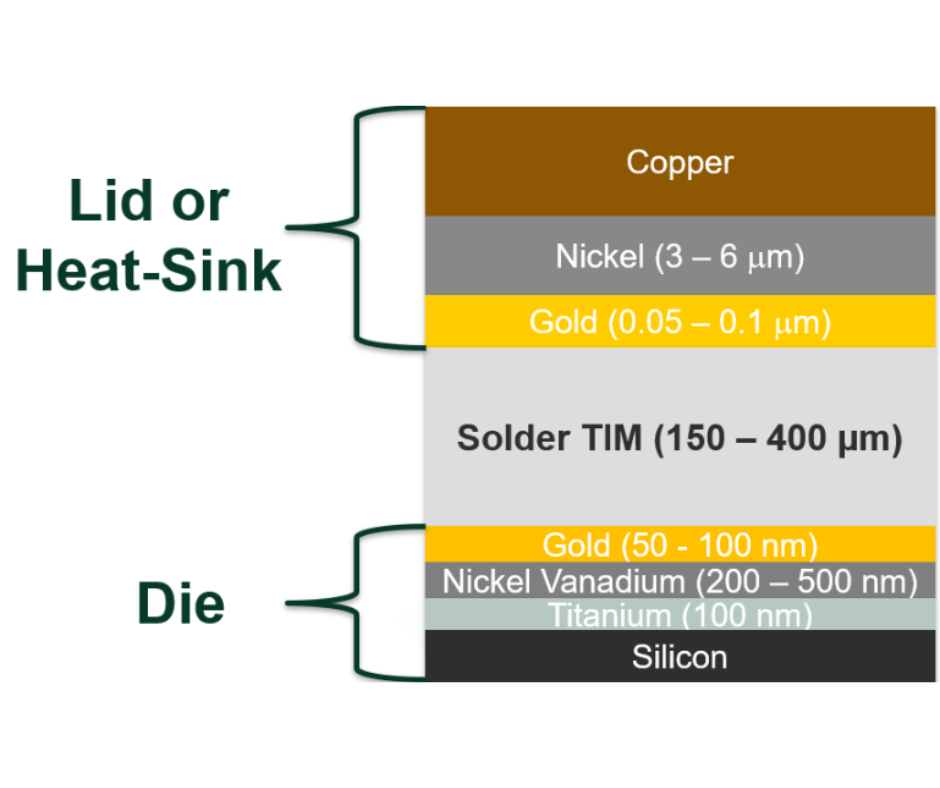
Figura 1: Apilamiento típico de metalización para TIM de soldadura en una aplicación TIM1 o TIM1.5.
En el lado del chip de silicio, es habitual ver algún tipo de metalización por pulverización catódica de titanio, níquel-vanadio (NiV) u oro en la parte posterior (BSM).
- La capa de titanio actúa como capa de adhesión entre las capas de silicio y NiV.
- La capa NiV es la capa soldable responsable de la formación del compuesto intermetálico de indio-níquel (IMC). Si no está seguro del grosor que debe tener esta capa, una opción segura es aumentar el grosor del níquel.
- Por último, la fina capa de oro actúa como capa de pasivación, lo que evita la oxidación de la capa de NiV soldable y favorece una larga vida útil antes del proceso de soldadura. Se recomienda mantener esta capa lo más fina posible, conservando al mismo tiempo sus características de pasivación. Al igual que la fragilidad del oro-estaño que se observa en el montaje de placas de circuito impreso (PCBA) y en la tecnología de montaje superficial (SMT), los IMC de indio-oro son extremadamente frágiles. Un exceso de estos IMC puede provocar pequeñas microfisuras en la interfaz y dar lugar a fallos mecánicos prematuros.
En cuanto al disipador térmico, la tapa o la superficie del difusor térmico integrado, lo habitual es utilizar algún tipo de niquelado químico (níquel-fósforo (NiP), 5-7 % de fósforo medio) o niquelado electrolítico. A continuación, se aplica una capa de oro por inmersión selectiva con unas dimensiones similares a las del chip de silicio o ligeramente superiores. Esto es importante porque la capa de oro actúa como una «máscara de soldadura metalúrgica».
Sin aplicar una fuerza excesiva a la soldadura de indio TIM durante la reflujo, la soldadura fundida humedece la superficie de oro recubierta selectivamente. Dado que ya se ha formado una interfaz con el intermetálicoIn2Au, la soldadura tiende a seguir humedeciendo esta superficie hasta que se agota la fina capa de oro. La figura 2 ilustra este fenómeno.

Figura 2: Izquierda: Vehículos de prueba con tapa de cobre chapada en ENIG con baño de oro selectivo en el centro. Derecha: Soldadura de indio después del reflujo, retirada del chip. El material de soldadura se adhirió a la superficie chapada en oro y no se extendió a la superficie chapada en níquel.
Al igual que en el lado del chip de silicio, se recomienda utilizar una capa de níquel más gruesa para formar el IMC dominante en la interfaz y una capa de oro muy fina para evitar fallos mecánicos prematuros. La figura 3 muestra una interfaz de unión de soldadura de indio puro utilizando una pila recomendada. La interfaz dominante en la superficie de níquel debe ser una IMC de indio-níquel o indio-níquel-oro. La capa de oro debe agotarse por completo después del proceso de reflujo, mostrando IMC de indio-oro que se han difundido en la mayor parte de la soldadura de indio.
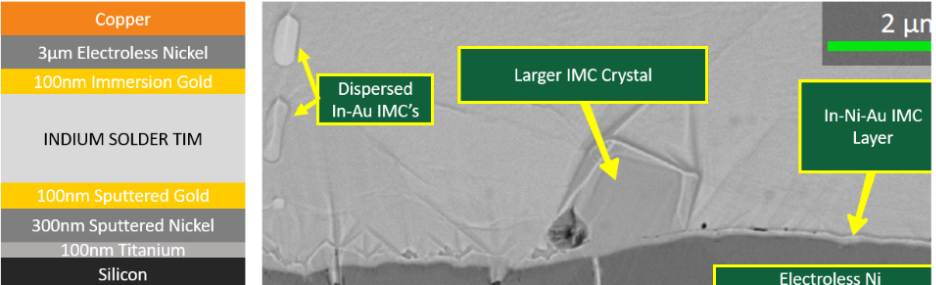
Figura 3: Izquierda: apilamiento de metalización de un vehículo de prueba ficticio TIM de soldadura. Derecha: primer plano de la sección transversal de la reacción interfacial entre el TIM de soldadura de indio y la metalización ENIG después de la soldadura.
Otras posibles metalizaciones para soldaduras de indio y indio-plata TIM
La pila de metalización de níquel-oro cuenta con un amplio respaldo científico, con más de dos décadas de investigación a sus espaldas, para ser exactos. No solo funciona, sino que se ha demostrado en múltiples ocasiones que proporciona una sólida resistencia a los ciclos térmicos y a los golpes. Dicho esto, otras opciones potenciales para superficies soldables podrían ayudar con las características de humectación de las aleaciones de soldadura a base de indio durante la reflujo.
El indio tiene naturalmente una alta tensión superficial en su estado fundido. Debido a esto, el indio fundido a menudo se adhiere a sí mismo en lugar de comenzar inmediatamente a formar un intermetálico con la delgada capa de oro soldable. Una vez que el indio se ha «agrupado» (y se ha producido la fluidez o la reducción del óxido), comenzará a formar un intermetálico con la capa de oro. Este fenómeno inicial de «agrupamiento» en sustratos de oro a veces puede causar fallos inesperados de humectación al definir por primera vez un proceso de reflujo.
Las aleaciones TIM de soldadura de indio-plata pueden ayudar en este sentido, pero a cambio se pierde algo de ductilidad y conductividad térmica global. Dicho esto, el indio es único desde el punto de vista metalúrgico debido a su facilidad para difundirse con otros materiales. Por ejemplo, algunos estudios describen una formación IMC de indio-plata que se forma fácilmente, no solo en el espacio TIM de soldadura, sino también en la galvanoplastia de indio sobre una capa gruesa de plata. Quizás el uso de capas finas de plata por inmersión o pulverización en lugar de oro podría ayudar a la humectación del indio en áreas de matriz grandes, manteniendo al mismo tiempo las IMC de indio-níquel como interfaz dominante. El indio también se humecta a sí mismo con bastante facilidad, por lo que también se podría explorar la posibilidad de utilizar la metalización de indio para estas aplicaciones.

Profundice en los TIM para soldadura
Dominar las complejidades de la metalización es solo una parte de la integración exitosa de los TIM de soldadura en sus diseños de paquetes de alto rendimiento. Para explorar este tema más a fondo y aprender cómo reducir la curva de aprendizaje desde el diseño hasta la producción, regístrese en nuestro próximo seminario web.
Únase a Kyle Aserian, ingeniero de desarrollo de aplicaciones de Indium Corporation, en «Cada grado cuenta: TIM de soldadura para diseños de paquetes con tapa (TIM1)», el 29 de octubre de 2025, a las 2 p. m. EST.
En esta sesión, aprenderás sobre:
- Descripción general del ensamblaje TIM1 (matriz a tapa/disipador térmico integrado).
- Integración de procesos y consideraciones de diseño para TIM de soldadura.
- Las claves del éxito para una unión soldada TIM1 fiable.
- Metodología de inspección, caracterización y evaluación de la fiabilidad.
Este seminario web es ideal para ingenieros de diseño, procesos o NPI que deseen integrar materiales de interfaz térmica de alto rendimiento en LGA, BGA u otros ensamblajes a nivel de chip.
Reserva tu plaza para descubrir todo el potencial de la IA, los videojuegos y la informática de alto rendimiento. ¡Regístrate ahora!
Fuentes:
Deppisch, et al; «Optimización de materiales y caracterización de la fiabilidad de un material de interfaz térmica con soldadura de indio para el encapsulado de CPU»; JOM; junio de 2006.



