Como todos sabemos, encontrar soluciones de gestión térmica se está convirtiendo en una cuestión cada vez más crítica, pero también en un reto cada vez mayor para la industria de los semiconductores, a medida que aumenta la densidad de potencia y se hace más compleja la estructura de los envases de semiconductores. La disipación térmica suele ser una gran preocupación a medida que aumenta la densidad de potencia de los dispositivos semiconductores y se eleva la temperatura de unión, lo que puede afectar negativamente al rendimiento y la fiabilidad del dispositivo semiconductor.
Se necesitan herramientas y capacidades eficaces para desarrollar soluciones de gestión térmica que garanticen que el rendimiento de los dispositivos semiconductores no se vea afectado negativamente por un rendimiento térmico deficiente. Tanto la simulación informática como las pruebas térmicas físicas desempeñan papeles importantes.
La simulación por ordenador puedeevaluar diferentes opciones de diseño, realizar análisis de sensibilidad y ayudar al diseñador a seleccionar la mejor solución entre esas múltiples opciones, sin tener que construir prototipos reales. Esto es muy útil en las primeras fases de desarrollo de un nuevo producto (como un dispositivo semiconductor), y contribuye en gran medida a acelerar el desarrollo del producto. Las ventajas de la simulación por ordenador son obvias y, por este motivo, se ha utilizado ampliamente como herramienta en el desarrollo de productos para dispositivos semiconductores a lo largo de los años.
Sin embargo, esto no quiere decir que la simulación por ordenador pueda sustituir por completo a las mediciones y pruebas físicas, porque la simulación por ordenador suele adolecer de varias limitaciones muy importantes. Para empezar, el modelado por ordenador siempre tiene que hacer un cierto número de suposiciones, relativas a las condiciones de contorno, las condiciones ambientales, las propiedades de los materiales, etc. A menudo, hay que hacer simplificaciones para una estructura compleja, sobre todo a medida que la estructura de los envases de semiconductores se hace más compleja. La integración heterogénea hace que estas cuestiones sean aún más difíciles, ya que a menudo intervienen en un mismo envase una gran variedad de materiales, interconexiones e interfaces, todos ellos elementos muy importantes en el ecosistema local para el rendimiento térmico del envase semiconductor.
Además, los modelos informáticos suelen tratar un problema estático, mientras que el problema real es siempre dinámico. Por ejemplo, las propiedades de los materiales, como los materiales de interfaz térmica (TIM), pueden variar y cambiar con el tiempo en función de las condiciones ambientales. El bombeo puede producirse bajo cargas térmicas y mecánicas. A menudo es difícil que la simulación por ordenador tenga en cuenta con precisión todas estas variaciones. También hay falta de uniformidad en los distintos elementos de la estructura: en el chip, en el disipador térmico, en el TIM, etc., y es difícil tener en cuenta con precisión todas estas condiciones no uniformes de la vida real en la simulación por ordenador.
Y lo que es más importante, la interfaz entre los distintos elementos y materiales (como la matriz, el TIM y el disipador de calor) de la estructura del encapsulado desempeña un papel importante en la disipación del calor, pero es bastante difícil de caracterizar con precisión en términos de resistencia térmica, por lo que los modelos informáticos a menudo tienen que hacer simplificaciones en estas complejas estructuras de encapsulado. Los dispositivos semiconductores funcionales de la vida real también son muy dinámicos en cuanto a su comportamiento térmico, especialmente cuando hay efectos interactivos, por ejemplo, entre las propiedades de los materiales y la temperatura del dispositivo, a la que afectan directamente las propiedades del material.
En la vida real, los modos de fallo y los mecanismos de degradación del rendimiento suelen ser complejos, y los modelos informáticos suelen centrarse en unos pocos modos de fallo conocidos. A veces, los modos de fallo imprevistos de un determinado paquete semiconductor pueden plantear riesgos importantes. Por ello, siempre es necesario realizar pruebas físicas de validación.
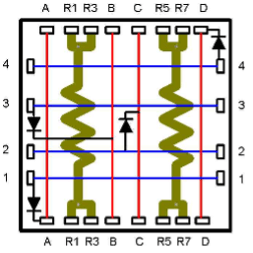
Por supuesto, las mediciones y pruebas térmicas plantean sus propios retos, sobre todo cuando las pruebas deben realizarse antes de que el dispositivo semiconductor real se haya desarrollado y fabricado, lo que puede llevar varios años. La práctica del sector ha sido desarrollar soluciones de gestión térmica -que requieren mediciones y pruebas térmicas- a medida que se desarrolla el chip. Los chips de pruebas térmicas (TTC) y los vehículos de pruebas térmicas (TTV) desempeñan un papel importante en este entorno simultáneo (Figuras 1 y 2).
Los TTC deben ser capaces de aproximarse a la entrada de potencia y a la distribución de la densidad de potencia del chip (normalmente no uniforme) y, al mismo tiempo, detectar con precisión la distribución de la temperatura (mediante sensores integrados) en todo el chip (con una resolución de hasta 1 mmx1 mm), en tiempo real.
Curiosamente, como los TTC son tan pequeños como 1 mm2, pueden ser muy útiles para simular el rendimiento térmico de los chiplets de los dispositivos semiconductores avanzados.
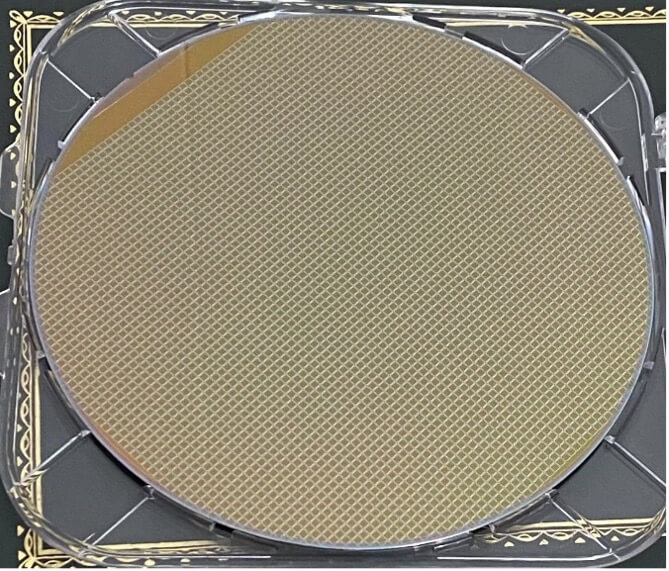
Los TTV, que constan de uno o varios TTC empaquetados, deben configurarse para representar la estructura de empaquetado prevista, y construirse y fabricarse utilizando los TIM, disipadores de calor y otros componentes reales que pueden afectar a la disipación de calor y al rendimiento térmico de todo el sistema. Las normas del sector, como las de la serie JESD51 de JEDEC, deben respetarse estrictamente para comparar soluciones de gestión térmica alternativas. Los TTV también pueden construirse para una aplicación específica con la estructura de encapsulado real, que a menudo es diferente (y más compleja) de las estructuras de encapsulado definidas en la norma. Como tales, los TTV pueden tener muchas variedades específicas (Figura 3).
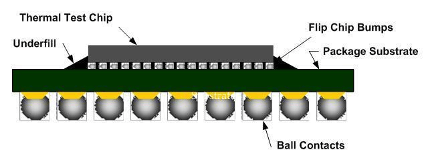
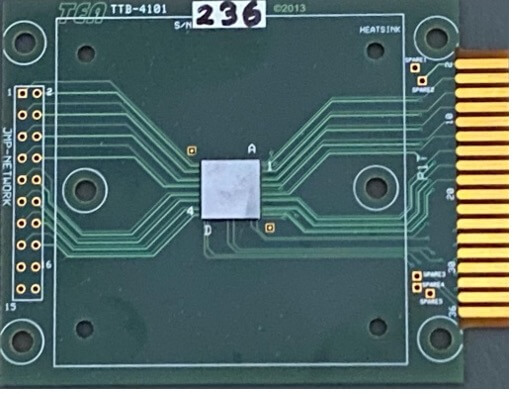
Las placas de carga térmica (TLB) son herramientas de diseño de gestión térmica a nivel de sistema para el diseño simultáneo de los aspectos mecánicos, eléctricos y térmicos de los sistemas electrónicos (Figura 5). La TLB suele diseñarse a medida para proporcionar una simulación física cercana a las condiciones de carga térmica reales mediante simuladores de fuentes de calor (HSS) resistivos y TTC.
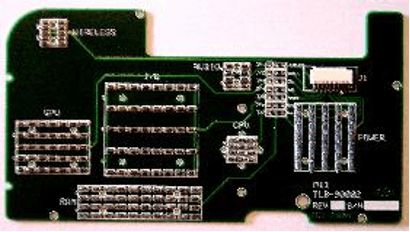
Estas herramientas son muy útiles para caracterizar el rendimiento térmico de los dispositivos y paquetes semiconductores. Utilizando los TTC y los TTV, y realizando mediciones y ensayos térmicos en entornos reales (como la entrada de potencia, las condiciones ambientales, el flujo de aire, etc.), se puede caracterizar la distribución espacial y temporal de la temperatura (incluidos los puntos calientes) en el chip, evaluar el rendimiento térmico de todo el encapsulado, valorar los distintos diseños del encapsulado, los TIM, los disipadores de calor, etc., y calibrar y validar el modelado informático.
En general, nuestro objetivo en el desarrollo de productos para dispositivos semiconductores es tener un "diseño óptimo" - ni sobrediseño (que afecta al coste, tamaño, peso y TTM), ni infradiseño (que afecta a la fiabilidad y al rendimiento del producto). La única manera de conseguirlo es mediante el uso eficaz de la simulación por ordenador ("gemelo digital") en tándem con las mediciones y pruebas térmicas - utilizando la "simulación física" ("gemelo físico").
Para más información, póngase en contacto con el Dr. Dongkai Shangguan.



