眾所周知,隨著功率密度的增加,半導體封裝結構變得更加複雜,對半導體產業而言,尋找散熱管理解決方案正變得越來越重要,但同時也是一個越來越具有挑戰性的問題。當半導體元件的功率密度增加,結點溫度升高時,散熱往往是一個非常值得關注的問題,這可能會對半導體元件的性能和可靠性造成不利影響。
我們需要有效的工具和能力來開發熱管理解決方案,以確保半導體元件的效能不會因熱效能不佳而受到負面影響。電腦模擬和物理熱測試都扮演著重要的角色。
電腦模擬可以評估不同的設計選項、執行敏感度分析,並協助設計人員在多個選項中選擇最佳解決方案 - 而無需建立實際的原型。這對於新產品 (例如半導體裝置) 的早期開發非常有用,並可大幅加速產品開發。電腦模擬的優點是顯而易見的,因此多年來,電腦模擬已被廣泛地運用在半導體裝置的產品開發上。
然而,這並不是說電腦模擬可以完全取代實體測量和測試,因為電腦模擬通常會受到幾個非常顯著的限制。首先,電腦模擬總是需要做一定數量的假設 - 關於邊界條件、環境條件、材料特性等。通常,必須對複雜的結構進行簡化 - 尤其是當半導體封裝結構變得越來越複雜時。異質整合使這些問題更具挑戰性,因為在單一封裝中通常會涉及大量不同的材料、互連和介面 - 這些都是半導體封裝熱性能的局部生態系統中非常重要的元素。
此外,電腦建模通常處理的是靜態問題,而實際問題總是動態的。例如,材料特性(如熱介面材料 (TIM))會隨環境條件的變化而變化,並隨時間而改變。在熱負載和機械負載下,可能會發生抽出現象。電腦模擬通常難以精確考慮所有這些變化。此外,結構中的各個元素 - 晶片、散熱器、TIM 等也會有不均勻的情況,而電腦模擬很難精確地將所有這些現實生活中的不均勻情況都計算在內。
非常重要的是,封裝結構中各種元件和材料 (如裸片、TIM 和散熱片) 之間的介面在散熱方面扮演著重要的角色,但卻很難精確表徵其熱阻,而電腦建模往往需要對這些複雜的封裝結構進行簡化。現實生活中的功能性半導體元件在熱行為上也是非常動態的,尤其是當有互動效應時,例如材料特性與元件溫度之間的互動效應,而材料特性會直接影響元件溫度;這些動態與互動現象對於電腦建模而言是很難精確捕捉的。
在現實生活中,失效模式和效能衰減機制通常都很複雜,而電腦建模通常只會著重於幾種已知的失效模式。對於特定半導體封裝而言,無法預見的失效模式有時可能會造成重大風險。因此,總是需要進行實體測試來驗證。
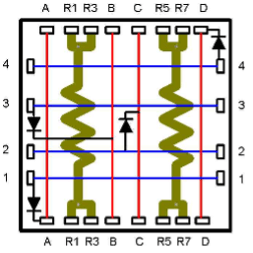
當然,熱量測量和測試也有其本身的挑戰 - 尤其是當測試需要在實際的半導體元件開發和製造之前進行時 - 這可能需要數年的時間。業界的做法是在開發晶片時,同時開發熱能管理解決方案 (需要進行熱量測量與測試)。熱測試晶片 (TTC) 和熱測試車 (TTV) 在此同時進行的環境中扮演重要角色 (圖 1 和圖 2)。
TTC 必須能夠近似晶片的功率輸入和功率密度分佈 (通常是不均勻的),同時即時精確感測整個晶片的溫度分佈 (使用整合式感測器) (解析度低至 1mmx1mm)。
有趣的是,由於 TTC 小至 1平方毫米,因此對於模擬先進半導體裝置的晶片熱性能非常有用。
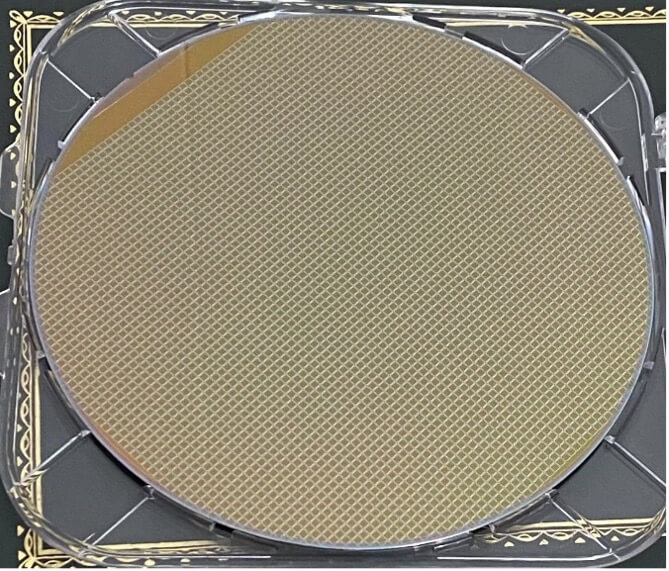
由封裝 TTC 組成的 TTV 必須配置為代表預期的封裝結構,並使用實際的 TIM、散熱片和其他可能影響整個系統散熱和散熱效能的真實元件來構建和製造。在比較其他熱管理解決方案時,必須嚴格遵守 JEDEC JESD51 系列標準等業界標準。TTV 也可以針對特定應用,以真實封裝結構來建構 - 這通常與標準中定義的封裝結構不同 (而且更複雜)。因此,TTV 可以有許多特定的種類 (圖 3)。
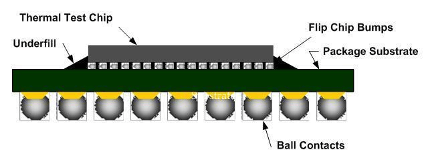
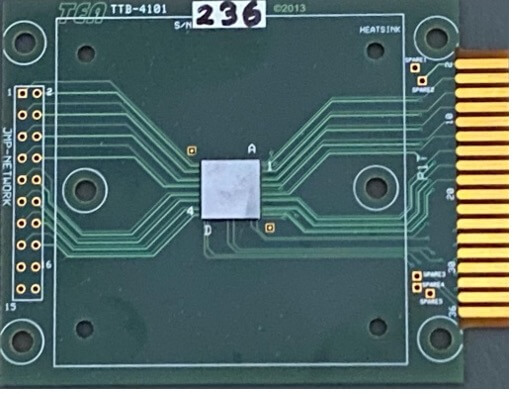
熱負載板 (TLB) 是系統層級的熱能管理設計工具,用於同時設計電子系統的機械、電氣和熱能方面 (圖 5)。TLB 通常是客製化設計,使用電阻式和 TTC 熱源模擬器 (HSS) 提供實際熱負載條件的近似物理模擬。
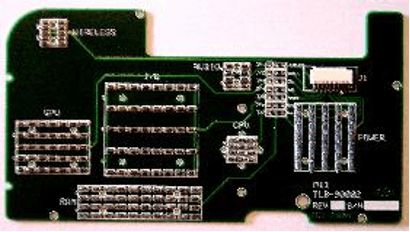
這些工具對於表徵半導體裝置和封裝的熱表現非常有用。使用 TTC 和 TTV,並透過在真實環境 (如電源輸入、環境條件、氣流等) 中執行熱量測量和測試,可以表徵晶片上的空間和時間溫度分佈 (包括熱點),評估整個封裝的熱性能,評估各種封裝設計、TIM、散熱片等,並校正和驗證電腦建模。
總體而言,我們在半導體元件產品開發上的目標是「最佳設計」 - 而不是過度設計 (會影響成本、尺寸、重量和 TTM) 或設計不足 (會影響可靠性和產品效能)。要達到這個目標,唯一的方法就是有效地使用電腦模擬(「數位孪生」),並配合熱量測量和測試 - 使用「實體模擬」(「實體孪生」)。
如需更多資訊,請聯絡上官東凱博士。



