ご存知のように、半導体パッケージング構造が複雑化する一方で電力密度が高まるにつれて、熱管理ソリューションの発見は半導体産業にとってますます重要かつ困難な課題となっています。半導体デバイスの電力密度が増加し、接合部温度が上昇するにつれ、熱放散はしばしば大きな懸念となり、半導体デバイスの性能と信頼性に悪影響を及ぼしかねません。
半導体デバイスの性能が熱性能の低下によって悪影響を受けないようにするための熱管理ソリューションを開発するには、効果的なツールと機能が必要です。コンピュータ・シミュレーションと物理的な熱試験の両方が重要な役割を果たします。
コンピュータ・シミュレーションは、さまざまな設計オプションを評価し、感度分析を実行し、実際のプロトタイプを作成することなく、設計者が複数のオプションの中から最適なソリューションを選択するのに役立ちます。これは、新製品(半導体デバイスなど)の開発初期に非常に有効であり、製品開発のスピードアップに大きく貢献します。コンピュータ・シミュレーションの利点は明らかであり、そのため、コンピュータ・シミュレーションは、長年にわたって半導体デバイスの製品開発ツールとして広く活用されてきました。
しかし、コンピュータ・シミュレーションが物理的な測定や試験に完全に取って代われるというわけではありません。なぜなら、コンピュータ・シミュレーションには通常、いくつかの非常に大きな制約があるからです。そもそも、コンピュータ・モデリングは、境界条件、周囲条件、材料特性などに関して、常に一定の仮定を置く必要があります。特に半導体パッケージング構造が複雑になればなるほど、複雑な構造を単純化しなければならないことが多い。異種集積では、多種多様な材料、相互接続、インターフェースが1つのパッケージに含まれることが多く、半導体パッケージの熱性能にとって局所的なエコシステムで非常に重要な要素であるため、これらの問題はさらに難しくなります。
さらに、コンピュータモデリングでは静的な問題を扱うことが多いが、実際の問題は常に動的なものである。例えば、サーマルインターフェイス材料(TIM)などの材料特性は、環境条件下で変化し、時間とともに変化する可能性がある。パンプアウトは、熱負荷や機械的負荷のもとで発生する可能性があります。コンピューター・シミュレーションでは、こうした変化をすべて正確に考慮することは困難な場合が多い。また、チップ内、ヒートシンク内、TIM内など、構造を構成するさまざまな要素には不均一性があり、コンピュータ・シミュレーションでこれら現実の不均一な条件をすべて正確に考慮することは困難です。
非常に重要なのは、パッケージ構造内の様々な要素や材料(ダイ、TIM、ヒートシンクなど)の界面が放熱に重要な役割を果たすことですが、熱抵抗の観点から正確に特性評価することは非常に難しく、コンピュータモデリングでは、このような複雑なパッケージ構造を単純化する必要がしばしばあります。また、現実の機能半導体デバイスは、その熱挙動が非常に動的であり、特に、材料の特性と、材料の特性が直接影響するデバイス温度との間に相互作用効果がある場合、このような動的かつ相互作用的な現象をコンピュータモデリングで正確に捉えることは困難です。
実生活では、故障モードや性能劣化メカニズムは複雑であることが多く、コンピュータ・モデリングは通常、いくつかの既知の故障モードに焦点を当てている。特定の半導体パッケージの予期せぬ故障モードは、時として重大なリスクをもたらすことがある。そのため、検証には常に物理的なテストが必要となります。
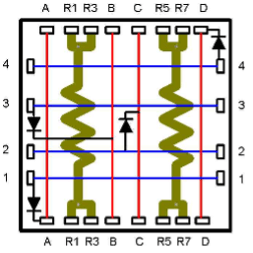
特に、実際の半導体デバイスが開発・製造される前にテストを行う必要がある場合は、数年かかることもあります。業界の慣例では、チップの開発と同時に、熱測定と試験を必要とする熱管理ソリューションを開発してきました。サーマルテストチップ(TTC)とサーマルテストビークル(TTV)は、このコンカレント環境において重要な役割を果たしています(図1、2)。
TTCは、チップの電力入力と電力密度分布(通常は不均一)を厳密に近似し、同時にダイ全体の温度分布(統合センサーを使用)を(1mmx1mmまでの分解能で)リアルタイムで正確に感知できなければならない。
興味深いことに、TTCは1mm2と小さいため、先端半導体デバイスのチップレットの熱性能をシミュレーションするのに非常に有用である。
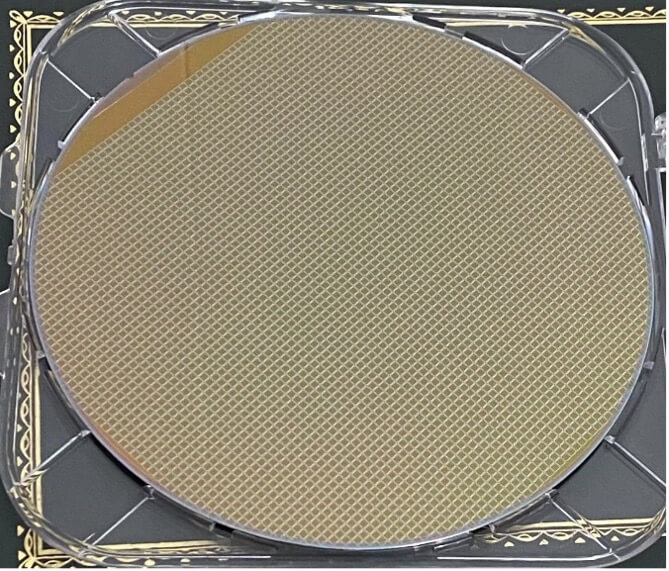
パッケージ化されたTTCからなるTTVは、意図されたパッケージ構造を表すように構成され、実際のTIM、ヒートシンク、およびシステム全体の放熱と熱性能に影響を与えるその他の実際のコンポーネントを使用して構築され、製造されなければならない。代替の熱管理ソリューションを比較するためには、JEDEC JESD51シリーズ規格などの業界標準を厳密に遵守する必要があります。TTVはまた、実際のパッケージ構造(多くの場合、規格で定義されたパッケージ構造とは異なる(より複雑な)構造)を用いて、特定のアプリケーション向けに構築することもできます。そのため、TTVには多くの種類があります(図3)。
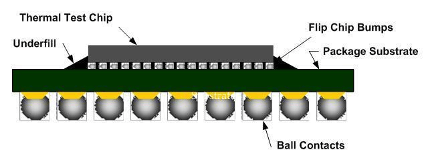
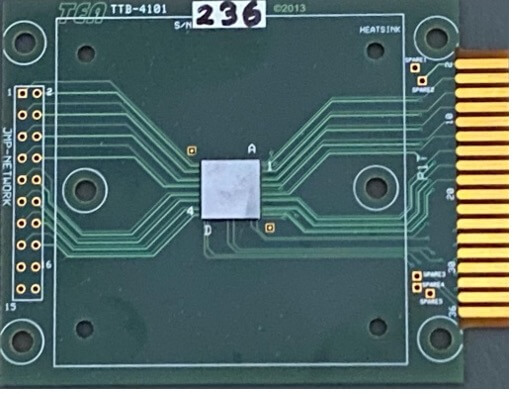
サーマルロードボード(TLB)は、電子システムの機械的、電気的、熱的側面を同時に設計するためのシステムレベルの熱管理設計ツールです(図5)。TLBは通常、抵抗式およびTTC熱源シミュレータ(HSS)を使用して、実際の熱負荷条件に近い物理シミュレーションを提供するようにカスタム設計されています。
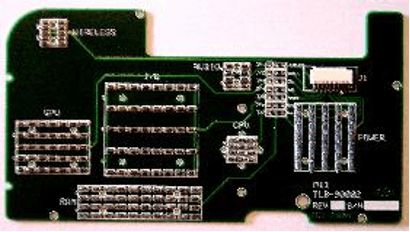
これらのツールは、半導体デバイスやパッケージの熱性能を評価するのに非常に有用です。TTCとTTVを使用し、実際の環境(電力入力、周囲条件、気流など)で熱測定と試験を行うことで、チップ上の空間的および時間的な温度分布(ホットスポットを含む)を特性化し、パッケージ全体の熱性能を評価し、さまざまなパッケージ設計、TIM、ヒートシンクなどを評価し、コンピュータモデリングを校正および検証することができます。
全体として、半導体デバイスの製品開発における目標は「最適設計」であり、過剰設計(コスト、サイズ、重量、TTMに影響)や過小設計(信頼性や製品性能に影響)ではないことです。そのためには、コンピュータ・シミュレーション(「デジタル・ツイン」)と熱測定・試験(「フィジカル・シミュレーション」(「フィジカル・ツイン」)を効果的に併用するしかありません。
詳細については、Dongkai Shangguan博士までお問い合わせください。



