半導体パッケージング&アセンブリ
2.5Dおよび3Dパッケージング
半導体デバイスの性能、集積度、システム能力を高めるため、業界では2.5Dや3Dパッケージの採用が進んでいる。これは、複数の集積回路(IC)を1つのパッケージに統合するもので、異種集積の時代における小型化の重要なトレンドとなっている。インジウム・コーポレーションは、半導体グレードのフラックス、ペースト、関連材料の設計、調合、製造、供給における世界的リーダーとして、お客様のパッケージング・ニーズにお応えする実績あるエキスパートです。
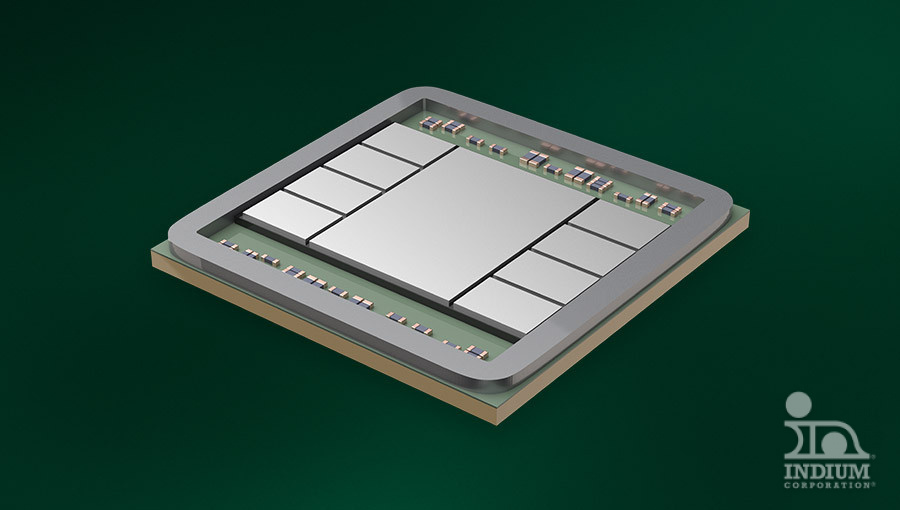

概要
2.5Dおよび3Dパッケージングの力で半導体集積化を進める
ムーア以上に、2.5Dと3Dパッケージングは、性能とシステム能力の向上を目的とした洗練された半導体集積技術である。これらの技術は、多様なプロセスノードを単一のパッケージに組み込むことを可能にする。2.5Dパッケージではダイを横に並べて配置し、3Dパッケージではダイを垂直に積み重ねる。インジウムコーポレーションは、一流の顧客や装置パートナーと協力して、急速に進化するこの領域で材料と組立プロセスを革新し、改良しています。
メリット
戦略的提携を通じて包装資材のイノベーションを推進
戦略的パートナーシップ
インジウム・コーポレーションは、先進的なパッケージング要件に合わせた最先端材料の開発を、大手顧客や設備パートナーから支援されています。
実証済み
プロセス実証済みの材料は、すでに高度なパッケージング組立に使用されている。
高利回り
当社の堅牢で安定した材料は、特に困難なパッケージング組立工程において、望ましい歩留まりを実現します。
優れた技術サービス
高歩留まりを達成するための材料選択とプロセスの最適化に必要なサポートを提供します。
関連商品
インジウム・コーポレーションは、2.5Dおよび3Dパッケージング・ソリューションの需要に合わせた包括的な材料を提供しています。
関連アプリケーション
Back to the Basics: Flux
During my first few weeks as a Technical Support Engineer at Indium Corporation, I researched extensively and consulted with my team to find out when flux should be used and why it’s essential to
Ramp-to-Peak: The First Thought in a Reflow Profile
Folks, I am working on a book with my Indium Corporation colleagues on tackling soldering defects in electronics.It is a follow up to our The Printed Circuits Assembler's Guide to Solder Defects.
システム・イン・パッケージのための革新的先端パッケージング材料の開発
アドバンスド・パッケージングは、さまざまな相互接続技術がヘテロジニアス(異種接合)に向かって進化し続けている。
半導体パッケージングとエレクトロニクス製造におけるML/AI
半導体パッケージング技術が "More than Moore "時代に進化するにつれ、多くの先進的なプロセスが製造上の課題となっている。多くの場合、精密ダイ
ボールグリッドアレイの一般的な故障とその回避方法
ボール・アタッチ・プロセスは、フリップ・チップ・アセンブリや2.5Dおよび3Dのような他のプロセスほどエキサイティングではないことは認める。