互连可靠性对半导体封装和电子系统的可靠性至关重要。
如果我们看一下从芯片到系统的生命周期--从集成电路设计、晶圆制造和封装,到电路板组装和系统集成--其中的共同要素就是保证电子系统现场可靠性的 "互连线"。半导体封装的主要目的是在不同层次上产生从芯片到系统的互连:从芯片到基板,到元件端接,再到 PCB 和系统,包括各种形式的互连,如再分布层 (RDL)、硅通孔 (TSV)、导线键合、焊点、凸块/球、直接铜键合等。也可以通过光子技术(而不是电子技术)。在系统层面,连接器、光纤和电缆等互连器件对电子系统的可靠性起着重要作用。
从本质上讲,半导体封装是沿着从集成电路到系统的信号链建立互连,用于信号和功率分配。在过去的六十年中,半导体封装随着互连线路不断缩短的总体趋势而发展。"少就是摩尔"--微型化有利于提高性能、功耗、面积、成本和可靠性(PPACR)。
为了保证从芯片到封装的互连可靠性,我们需要首先考虑芯片封装相互作用(CPI),因为用于芯片电气性能的低介电材料具有较差的机械性能。当芯片经过各种封装步骤时,所产生的机械应力会传播到芯片上,造成错位、变形和介电断裂。为了解决 CPI 问题,我们需要通过多层次多尺度建模(图 1)来评估从基板和焊接凸点到芯片介电层的应力传播。
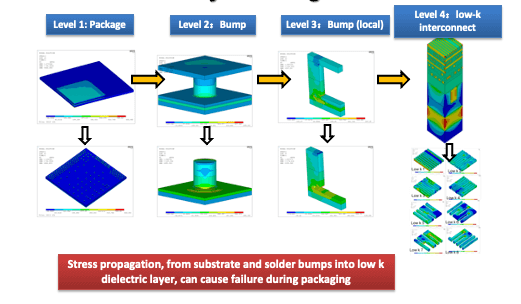

对于焊料互连的可靠性,我们需要关注各种循环加载条件,例如热循环(通过蠕变-疲劳相互作用导致低循环疲劳)以及循环弯曲和振动(导致高循环疲劳),它们通过裂纹的产生和扩展导致焊点失效(图 2)。我们还需要关注动态机械加载条件,如跌落和机械冲击,它们会导致基板高频弯曲和焊点断裂。动态机械可靠性需要考虑的重要因素包括应变率依赖性、应力集中和界面金属间化合物 (IMC)。

虽然无铅 SAC(锡/银/铜)合金可以满足许多应用的要求,但在高应力水平方面却存在不足,因为 SAC 的蠕变应变率会随着应力的增加而增加,在某些高应力水平下会超过锡铅的蠕变应变率。出现这些高应力水平的原因可能是热膨胀系数(CTE)不匹配程度高、热循环范围大、元件尺寸大或对位高度低。更多详情可参阅《无铅焊料互连可靠性》一书(图 3)。
在此背景下,我们开发出了一种新的焊料系统,通过沉淀硬化和溶液硬化提高了可靠性,而且配制的焊膏具有极低的空洞率。由于回流焊工艺与 SAC 工艺非常相似,因此它被认为是一种 "即插即用 "的焊料解决方案。这种新材料在热循环过程中延迟了裂纹的产生,并减缓了焊料互连中裂纹的扩展,因此具有卓越的可靠性能。

通常情况下,可能需要较低的焊接温度来降低对元件的热影响,并减少基板的翘曲,因为翘曲会导致许多质量问题。在某些情况下,还需要使用低温焊料来进行被称为 "分步焊接 "的分层工艺。低温焊料还有助于降低装配过程中的能耗。由于脆性,现有的低温合金(如锡铋)在跌落冲击测试中表现不佳。目前已开发出一种新材料,用于峰值温度为200-210oC的回流焊,在热循环和机械冲击下性能优越。
除机械负载外,电气负载也会造成互连可靠性问题。在电流作用下会发生电迁移,导致互连故障(图 4),某些焊料合金(如锡铋)容易发生电迁移。随着微型互连中电流密度的增加,这种问题也越来越令人担忧。

有时,故障的发生不是因为没有预期的互连,而是因为存在意外的互连。锡须(图 5)就是这样一个例子,它是一种自发形成的丝状物,生长非常缓慢,但几年后就会导致故障。

另一种可能出现的故障是印刷电路板或基板中的导电阳极丝(CAF),在这种情况下,铜丝(图 6)在电偏压作用下从一个通孔通过玻璃纤维和环氧树脂之间的间隙生长到邻近的通孔,并伴有水分凝结。同样,树枝状突起(图 7)也会在存在助焊剂残留物(提供离子污染)的情况下,通过电化学迁移在电偏压下生长,从而造成电路 "短路"。
随着我们进入 5G 和 6G 时代,磁通残留物对高频电路信号完整性的影响尤其引人关注。助焊剂残留物可为高频信号提供替代路径(图 8),助焊剂残留物对信号完整性的影响对湿气的存在非常敏感。这种情况和其他考虑因素推动了超低残留(ULR)免清洗助焊剂配方的发展,这种助焊剂配方足以润湿,但对电路的影响却大大降低,而且无需清洗即可进行成型和底部填充。

在细间距互连(10 微米以下)方面,一个非常令人兴奋的发展是直接铜互连,如 "混合接合"。这种工艺由于互连路径短,插入损耗低,因此具有卓越的互连可靠性和信号完整性。
随着电子产品在应用中变得越来越普遍,必须全面考虑互连可靠性的环境条件--从机械和热机械条件到电气和电化学条件--这些条件会导致不同的失效模式和机制。随着异质集成的日益普及,同一封装中的互连器件(具有不同的几何形状、材料和接口)也越来越多样化,同时出现了复杂的(通常是交互式的)可靠性失效模式和机制。这些因素将影响半导体器件的可靠性工程,包括设计、材料、工艺和测试。
欲了解更多信息,请联系 Dongkai Shangguan[email protected]。(更多详情,请参阅我在 2022 年 IEEE 电子封装与光子学可靠性研讨会上的特邀主题演讲)。



