随着功能密度和功率密度的增加,尤其是采用先进封装后,热管理正成为半导体器件面临的一项日益严峻的挑战。热测试芯片(TTC)是为大功率半导体器件开发热管理解决方案的重要推动力。
如何制造 TTC?
由美国制造的硅晶圆(图 1)制成的 TTC 可以精确模拟真实半导体芯片的尺寸和不均匀功率分布(如热点),并通过嵌入式片上传感器对芯片进行实时温度测量。TTC 是一个模拟 ASIC,由单元单元组成(图 2 和图 3),每个单元单元的功率输入和温度都可直接寻址,因此能够在芯片上进行可配置的功率分配和现场温度测量--小到一个单元单元的规模。
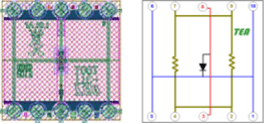
单元池中的热源采用金属膜电阻器,以提高整个晶片的均匀性和匹配性,其相对稳定的温度系数可在热测量过程中实现恒定的功率耗散。热源的布局也符合 JEDEC JESD51-4 标准。温度传感二极管 (TSD) 战略性地安装在 TTC 中,可同时精确测量多个位置的芯片温度。
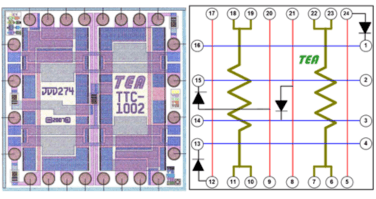
由于单元单元可以任意组合排列,因此 TTC 的尺寸可以与实际芯片的尺寸相匹配(最大可达 50 毫米 x 50 毫米,必要时甚至更大)。TTC 的每个单元中都集成了加热器和传感器,其精度和准确性可以精确模拟真实半导体芯片的热行为,因此是在新芯片开发过程中(通常需要数年时间)同时开发热管理解决方案的绝佳工具。
使用热测试芯片制造测试车辆
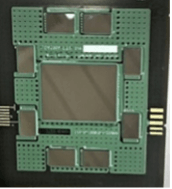
有了 TTC(设计用于线键合或倒装芯片连接),就可以开发各种封装形式的热测试车 (TTV),如 BGA、LGA、COB 等,以及每个封装多芯片的热测试车(图 4),以模拟异构集成中常用的系统级封装 (SiP)。
TTC 和 TTV 能够对整个芯片进行可配置的功率分配和同步温度测量,因此对于采用各种热管理解决方案(热界面材料 (TIM)、散热器、蒸发室、热管、冷板、液体冷却等)的半导体封装和器件而言,TTC 和 TTV 对于热特性分析(稳态和瞬态)和评估(包括功率和/或温度映射)非常有用。它们对于验证热模拟和建模也非常有用。此外,还可以在编程设置中进行功率循环,以评估各种热管理解决方案的可靠性能。
玻璃中间膜的热测试芯片:案例研究
事实上,TTC 也能满足先进封装的需求。在佛罗里达州奥兰多市举行的 2023 年电气和电子工程师学会第 73 届电子元件与技术大会(ECTC)上,来自佐治亚理工学院和宾夕法尼亚州立大学的研究人员在题为"Bottom Side Cooling for Glass Interposer with Chip Embedding Using Double-sided Release Process for 6G Wireless Applications "的论文中介绍了他们最近的一个研究项目,该项目使用热工程协会(TEA)的 TTC 开发了一种芯片嵌入式玻璃中间膜工艺(图 5)。在玻璃中间膜中,在玻璃基板上制备通腔,然后将 TTC 嵌入通腔,并通过顶部的再分布层 (RDL) 连接。为进行热管理,使用 TIM 接口将铜散热器连接到暴露的 TTC 背面。对嵌入式 TTC 功率密度进行了测试,以了解各种传热系数(28.8~261.3W/m2K之间)的冷却能力。
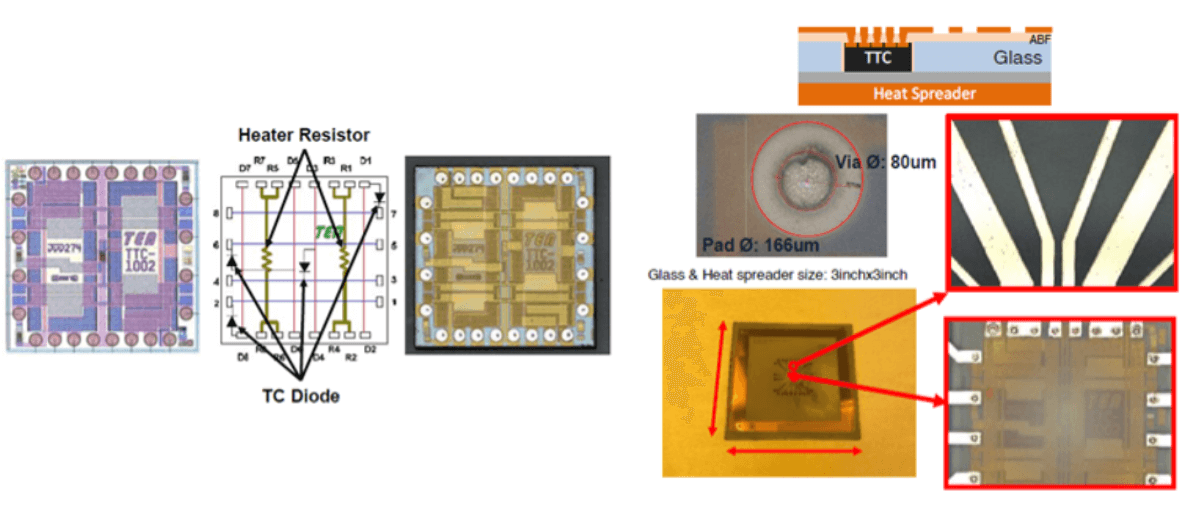
总之,随着半导体芯片和先进封装的不断发展--功率密度不断提高,封装配置更加复杂,TTC 和 TTV 将能够密切仿效半导体芯片和先进封装。堆叠芯片和 2.5D/3D 封装芯片形式的 TTC 目前正在开发中。



