隨著半導體封裝技術在 "More than Moore "時代的演進,許多先進製程在製造過程中提出了挑戰。舉例來說,精密晶粒接合的挑戰往往導致良率、產量以及最終製造成本的取捨。精密對位已成為多種先進異質整合技術的關鍵能力之一,例如 2.5D/3D、光學組裝等。
對於先進封裝而言,多年來隨著高密度設計的封裝間距不斷縮小,更細間距 (例如 10µm 或以下) 的晶粒接合對位已成為一個重要的挑戰領域。舉例來說,對於倒裝晶片晶粒而言,在大多數的接合設備上,高準確度與成本之間存在一個折衷 -- 間距越小,晶粒接合對位的過程就越慢。
高密度扇出製程是另一種需要高精度晶粒接合的製程。高密度扇出製程是另一種需要高精度晶粒接合的製程。一旦對晶粒排列精度的要求低於 1μm,良率和產量方面的挑戰就會變得更加嚴峻。以混合接合為例,設備的對位精度可能會成為互連間距的限制因素,從而在某些情況下限制了設計要求的實現。晶片的出現對批量製造提出了更大的挑戰。
高精度對準也是收發器、光纖、MEMS、LiDAR、LED、光學成像等應用的重要能力。這些重要的應用同時需要高精度的對位與高產量,進一步突破設備的產能極限。以光學組裝為例,鏡頭連接、發射器位置、接收器位置、接合線厚度 (BLT) 等都是製程良率與產品性能的關鍵參數。
機器學習和人工智慧 (ML/AI) 可以成為非常有效的工具,協助解決這些挑戰。
機器學習著重於尋找資料中的模式,並利用這些模式進行預測。ML/AI 可以在半導體封裝和電子製造中有許多重要的應用。這些應用範圍從供應鏈管理、新產品導入 (NPI)、生產規劃、可追溯性,到預測性維護、生產力提升,以及製程改善、良率提升等等。

其中一個範例是 ML/AI 平台,可利用即時機器資料和作業資料 (例如實際放置位置、週期時間等) 在機器上 (即「邊緣」) 開發 ML 模型。透過適當的通訊協定與機器資料來源 (如現有的感測器、致動器、PLC、日誌資料等) 進行簡易的介面連接,可提供大量的即時資料 (如加速度、旋轉、輸送帶速度、夾爪位置、貼合頭動作、環氧噴劑壓力,以及各種機器零件的其他即時參數),這些資料對機器和製程的效能非常重要。即時資料擷取和多變數資料處理,結合資料轉換、拼接和過濾,為建立 ML 模型的大量資料虛擬化提供了穩健的基礎 (圖 1)。
該平台在毫秒級的時間內收集資料,並在實際的製造環境中,在不中斷生產的情況下,在數天或數週內建立 ML 模型。ML 模型透過即時的持續改進,可用於預測性維護(透過異常偵測)(圖 2),更重要的是,可用於機器本身的自適應性控制(圖 3)。這些能力已被數家全球大型企業運用於半導體晶圓廠、先進封裝、收發器光纖、SMT 精密貼片等領域。在減少週期時間和機器停機時間的同時,還提高了對位精度和製程良率,實現了顯著的改進(圖 4)。
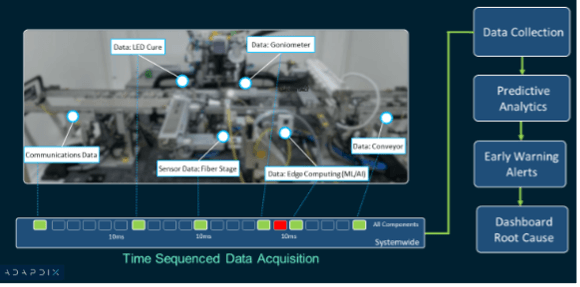


與此同時,可視化 (圖 5) 和可追蹤性 (圖 6) 可以實現從現場/線上級一直到機器感測器級的可視化和可追蹤性,其粒度是以前無法想像的,為優化和持續改進提供了前所未有的洞察力和智慧。此解決方案(或所需的「混合」解決方案)還可確保資料安全性和低延遲。由於此平台與機器無關,因此可部署到工廠生產線上的各種機器上。由於該平台與機器無關,因此可以部署到工廠生產線上的各種機器上,這一功能尤其強大,因為上下游機器現在可以「協作」進行整體同步優化。


透過各種使用案例,已證明在半導體晶圓廠、先進封裝、光學組裝及其他製程中,可利用邊緣的 ML/AI 平台大幅提升機器效能,以及具挑戰性製程的良率和產量,尤其是精密對位。當然,它也可用於診斷複雜、多變的製程問題,以及利用來自整條生產線各個工位的資料來縮短測試時間。



