随着半导体封装技术在 "超越摩尔 "时代的发展,许多先进工艺在制造过程中提出了挑战。例如,精密芯片接合方面的挑战往往导致产量、吞吐量和最终制造成本的权衡。精密对准已成为 2.5D/3D 和光学组装等多种先进异质集成技术的关键能力之一。
对于先进封装而言,多年来,随着高密度设计的封装间距不断缩小,更细间距(如 10 微米或以下)的芯片粘接对准已成为一个关键挑战领域。例如,对于倒装芯片裸片而言,大多数键合设备都需要在高精度与成本之间做出权衡--间距越小,裸片键合对准过程就越慢。
高密度扇出工艺是另一种需要高精度芯片接合的工艺。高密度扇出是另一种需要高精度芯片接合的工艺。一旦对芯片对准精度的要求低于 1μm,产量和吞吐量方面的挑战就会变得更加严峻。以混合键合为例,设备的对准精度可能成为互连间距的限制因素,从而在某些情况下限制了设计要求的实现。芯片的出现给批量生产带来了更大的挑战。
高精度对准也是收发器、光纤、微机电系统、激光雷达、发光二极管、光学成像等设备的关键能力。这些重要应用对高精度对准和高吞吐量同时提出了要求,进一步挑战了设备的能力极限。以光学装配为例,透镜连接、发射器位置、接收器位置、键合线厚度 (BLT) 等都是影响工艺产量和产品性能的关键参数。
机器学习和人工智能(ML/AI)可以成为帮助应对这些挑战的非常有效的工具。
机器学习的重点是发现数据中的模式,并利用这些模式进行预测。ML/AI 在半导体封装和电子制造领域有许多重要应用。应用范围包括供应链管理、新产品介绍 (NPI)、生产规划、可追溯性、预测性维护、生产率提高、流程改进、产量提高等。

其中一个例子是利用实时机器数据和操作数据(如实际放置位置、周期时间等)的 ML/AI 平台,以在机器现场(即 "边缘")开发 ML 模型。通过适当的通信协议与机器数据源(如现有传感器、执行器、PLC、日志数据等)轻松连接,可获得大量实时数据(如加速度、旋转、传送带速度、夹具位置、粘接头运动、环氧树脂涂敷压力以及各种机器部件的其他实时参数),这些数据对机器和流程性能非常重要。实时数据摄取和多变量数据处理与数据转换、拼接和过滤相结合,为构建 ML 模型的海量数据虚拟化奠定了坚实的基础(图 1)。
该平台在实际生产环境中以毫秒为单位收集数据,并在不中断生产的情况下,在数天或数周内建立 ML 模型。通过实时不断改进,ML 模型可用于预测性维护(通过异常检测)(图 2),更重要的是,可用于机器本身的自适应控制(图 3)。这些功能已被全球多家大型企业用于半导体工厂、先进封装、收发器光纤、SMT 精密贴装等领域。在提高对准精度和工艺产量,同时减少周期时间和机器停机时间方面取得了显著的改进(图 4)。
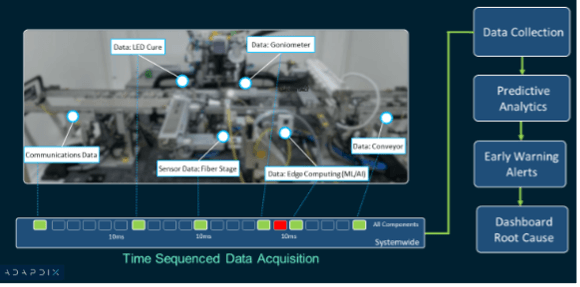


与此同时,可视化(图 5)和可追溯性(图 6)可以从现场/生产线级一直延伸到机器传感器级,其粒度是以前无法想象的,从而为优化和持续改进提供前所未有的洞察力和智能。这种解决方案(或根据需要的 "混合 "解决方案)还能确保数据安全和低延迟。由于该平台与机器无关,因此可以部署到工厂生产线上的各种机器上。由于该平台与机器无关,因此可以部署到工厂生产线上的各种机器上。这一点尤为强大,因为上下游机器现在可以 "协作 "进行整体同步优化。


通过各种使用案例,我们已经证明,在半导体制造、先进封装、光学装配等具有挑战性的工艺中,可以利用边缘 ML/AI 平台来显著提高机器性能以及产量和吞吐量,特别是在精密对准方面。当然,它还可用于诊断复杂的多变量工艺问题,以及通过利用整个生产线各个工位的数据来缩短测试时间。



