半導体デバイスの機能密度と電力密度が高まるにつれて、熱管理はますます重要な課題となっています。サーマル・テスト・チップ(TTC)は、ハイパワー半導体デバイスの熱管理ソリューションを開発するための重要なイネーブラーです。
TTCはどのように作られるのか?
アメリカで製造されたシリコンウェハー(図1)から作られたTTCは、実際の半導体チップのサイズと不均一な電力分布(ホットスポットなど)を正確にシミュレートすることができ、チップの温度をリアルタイムで測定するためのオンチップセンサーが組み込まれています。アナログASICであるTTCはユニットセルで構成され(図2、3)、各ユニットセルの電力入力と温度は直接アドレス指定が可能である。
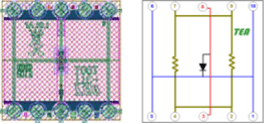
ユニットセル内の熱源には、ウェーハ全体の均一性と整合性を高めるために金属皮膜抵抗が使用されており、その比較的安定した温度係数は、熱測定の過程で一定の電力散逸をもたらします。また、熱源はJEDEC JESD51-4規格に準拠して配置されています。TTCに戦略的に配置された温度検出ダイオード(TSD)により、ダイの温度を複数箇所で同時に正確に測定できます。
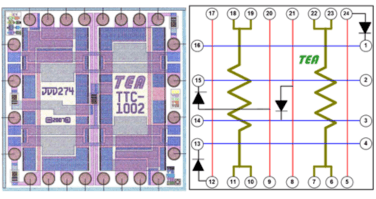
ユニットセルは任意の組み合わせで配列できるため、TTCは実際のチップのサイズに合わせて任意の大きさにすることができます(必要に応じて最大50mm x 50mmまたはそれ以上)。TTCは、各ユニットセルに内蔵されたヒーターとセンサーの精度が高く、実際の半導体チップの熱挙動を正確にシミュレートできるため、新しいチップの開発中(多くの場合、数年かかる)に熱管理ソリューションを同時開発するための優れたツールになります。
サーマル・テスト・チップを使ったテスト車両の製作
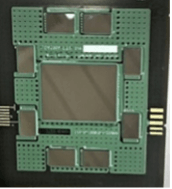
TTC(ワイヤーボンディングまたはフリップチップ取り付け用に設計)を使用すれば、BGA、LGA、COBなどのさまざまなパッケージ形式や、異種集積でよく使用されるシステム・イン・パッケージ(SiP)をシミュレートするためのパッケージごとのマルチチップ(図4)で、サーマル・テスト・ビークル(TTV)を開発できる。
TTCとTTVは、設定可能な電力分布とチップ全体の同時温度測定機能を備えており、熱界面材料(TIM)、ヒートシンク、ベーパーチャンバー、ヒートパイプ、コールドプレート、液冷など、さまざまな熱管理ソリューションを組み込むことができる半導体パッケージやデバイスの熱特性評価(定常状態および過渡状態)と、電力および/または温度マッピングを含む評価に非常に役立ちます。また、熱シミュレーションやモデリングの検証にも非常に役立ちます。さらに、様々な熱管理ソリューションの信頼性性能を評価するために、プログラムされた設定でパワーサイクルを行うことができます。
ガラスインターポーザーの熱試験チップ:ケーススタディ
実際、TTCは高度なパッケージングのニーズにも対応できる。フロリダ州オーランドで開催された第73回IEEE電子部品技術会議(Electronic Components and Technology Conference:ECTC)で発表された最近の研究プロジェクト「Bottom Side Cooling for Glass Interposer with Chip Embedding using Double-sided Release Process for 6G Wireless Applications」では、ジョージア工科大学とペンシルベニア州立大学の研究者が、Thermal Engineering Associates(TEA)のTTCをダイ内蔵ガラスインターポーザープロセスの開発に使用した(図5)。ガラス・インターポーザーでは、ガラス基板に貫通キャビティが用意され、TTCは貫通キャビティに埋め込まれ、上面の再配線層(RDL)を介して接続される。露出したTTCの裏面には、熱管理のためにTIMインターフェースを用いて銅製のヒートスプレッダが取り付けられている。28.8~261.3W/m2Kの範囲でさまざまな熱伝達係数を用いて、埋め込みTTCの電力密度をテストし、冷却能力を確認した。
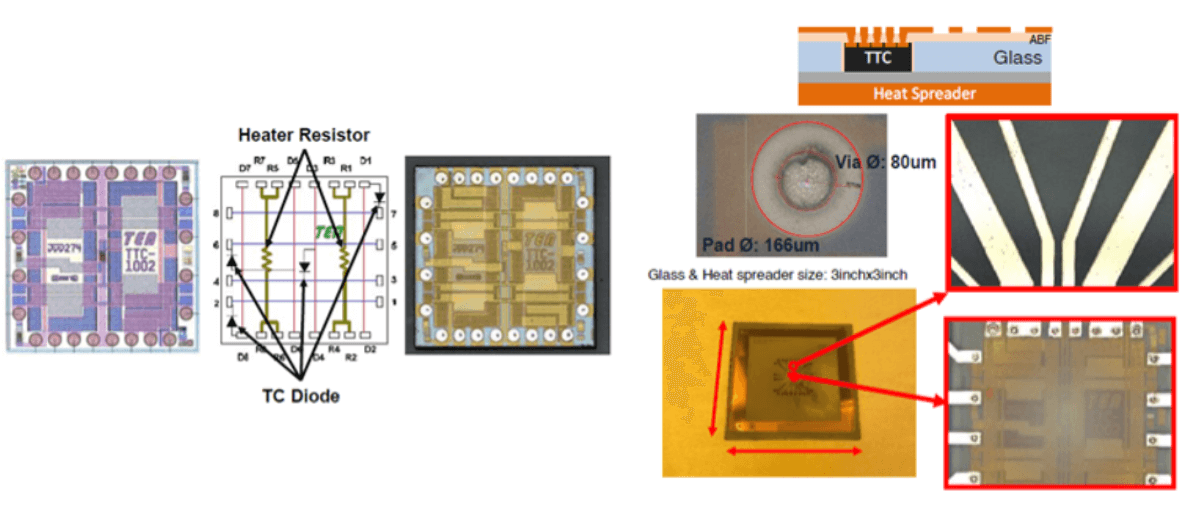
全体として、TTCとTTVは、半導体チップと高度なパッケージが進化するにつれて、電力密度が増加し、パッケージ構成がより複雑になるにつれて、それらを密接にエミュレートできるようになる。現在、2.5D/3Dパッケージの積層チップやチップレットの形のTTCが開発中である。



